Рецензенти: доц. Московського станкоинструментального інституту, канд техн наук Г. И. Гранітів; викладач Московського технікуму електронних приладів А. В. Закревская Гаркуша Ж. М
| Вид материала | Документы |
СодержаниеРозділ 5 кінетичні явища в напівпровідниках 5.6. Гальваномагнітні ефекти |
- Україна харківська міська рада харківської області виконавчий комітет управління освіти, 181.85kb.
- Гост 17623-87, 138.94kb.
- М. А. Ляшко доц., канд физ мат наук; Т. Н. Смотрова доц., канд, 2299.13kb.
- Надійності та безпеки в будівництві, 692.13kb.
- Гост 5382-91, 1729.88kb.
- Д. М. Лаковский (руководитель темы); И. В. Колечицкая; С. А. Резник, канд техн наук;, 203.82kb.
- Гост 14637-89: Прокат толстолистовой из углеродистой стали обыкновенного качества Технические, 310.23kb.
- Государственный стандарт союза сср здания и сооружения Методы измерения яркости, 278.78kb.
- Гост 26824-86, 248.28kb.
- Строительные нормы и правила отопление, вентиляция и кондиционирование, 2477.63kb.
Питомий опір напівпровідника містить у собі такі важливі параметри, як концентрації і рухливість носіїв заряду, і є одним з визначальних фізичних властивостей напівпровідникових матеріалів. Вимір питомого опору складає обов'язковий етап фізичних дослідженні напівпровідників.
Методика визначення питомого опору напівпровідників заснована на вимірі спадання напруги на деякій ділянці зразка, через який пропускають електричний струм. Основними методами вимірів є зондовые, і серед них найпоширеніший - четырехзондовый, головна перевага якого полягає в можливості проведення вимірів па зразках будь-якої форми і розмірів без нанесення на зразки металевих контактів.
Для проведення вимірів, па бічної поверхні напівпровідникового злитка сошлифовывается вузька смужка, на якій розміщаються чотири металевих зонди. Зонди розташовуються на одній прямій. Крайні зонди служать для підведення струму,
90
середні служать для виміру спадання напруги (мал. 4.18). При пропущенні струму через крайні зонди 1 і 4, між зондами 2 і 3 створюється спадання напруги Ux. За обмірюваним значенням спадання напруги і токи можна визначити величину питомого опору зразка.

Спадання напруги на підставі теорії потенціалів визначається по формулі

Якщо відстань між зондами однаково:

де р -питомий опір напівпровідника; st ,s, s3 - відстані між зондами. З її випливає

Основними ефектами, що впливають на величину вимірюваних опорів, є: високий перехідний опір контакту зонд - напівпровідник, теплові ефекти, розігрівши зразка минаючим струмом, генерація в області зонда неосновних носіїв заряду.
Для виключення впливу опору контактів па результати вимірів, спадання напруги Us вимірюють компенсаційним методом, що дозволяє визначити Ux при відсутності струму через контакт. Схема виміру питомого опору компенсаційним методом приведена на мал. 4.19.
91
Як компенсатор використовують потенціометр постійного струму, представлений на схемі умовно у виді R1. Нуль-індикатором служить високочутливий гальванометр А. Величина струму, що протікає через зразок, задається за допомогою джерела постійного струму Е\ і підтримується в процесі виміру на заданому рівні.
Для проведення виміру питомого опору необхідно установити робочий струм потенціометра, створюваний джерелом Е2 Для цього наявний у схемі джерело Е3 (нормальний елемент) за допомогою перемикача S1 підключають до резистора R2, через который протікає робочий струм потенціометра. На R2 створюються дві зустрічно включених напруги за рахунок протікання струму від Е2 і Ез- Змінюючи опір резистора R3, потрібно домогтися рівності цих напруг, тоді струм через гальванометр буде дорівнює нулю. Встановлений у такий спосіб робочий струм створює на резисторі R1 визначене спадання напруги, що при установці перемикача в положення 2 буде порівнюватися зі спаданням напруги, включеним зустрічно, що знімається зі зразка двома середніми зондами.
Змінюючи величину R1, потрібно знову домогтися рівності напруг, що буде відповідати відсутності струму через гальванометр. При вимірах установлюється такий струм, величина якого забезпечує прямий відлік питомого опору по потенціометрі.Для виключення впливу термо-э. д. з, що виникає в зразку, виміру питомого опору виконуються при двох напрямках струму, що протікає через зразок. Для цієї мети і схемі передбачений перемикач S2. Питомий опір знаходять як середнє значення двох вимірів для протилежних напрямків струму. Четырехзондовый метод можна застосовувати і для виміру опору тонких плівок.
Подібний цьому двухзондовый метод виміру. Розходження полягає в тім, що для протікання струму через зразок на його торці наносять омічні контакти. Операція ця досить трудомістка, тому двухзондовый метод в основному використовують у даний час для виміру питомого опору злитків напівпровідників і зразків правильної геометричної форми.
Для полікристалічних зразків зондовые методи не підходять тому, що їм присущи недоліки, зв'язані з виникненням у контактних зонах великих потенційних бар'єрів, що створюють побічні ефекти і результати вимірів, що спотворює. Питомий опір полікристалічних напівпровідників можна вимірювати безконтактними методами - індуктивним і їм кістковим. В основі цих методів лежать закони поширення електромагнітних ВЧ- і Свч-колебаний у провідній середовищі. Зв'язок між зразком і вимірювальною схемою при використанні струмів високої частоти здійснюється у виді ємнісного чи індуктивного зв'язку з окремими її елементами.
92
§ 4.9. ВИЗНАЧЕННЯ ТИПУ ЕЛЕКТРОПРОВІДНОСТІ НАПІВПРОВІДНИКІВ
Найбільш розповсюдженими методами визначення типу электроводности є методи термозонда і вольтамперных характеристик. Другий метод буде розглянутий у гл. 6.
Метод термозонда заснований на явищі виникнення термоелектродвпжущей сили в напівпровідниковій пластині,обладающи градієнтом температури. Розглянемо прямокутну попроводниковую пластину n-типу електропровідності. Один копей

пластини знаходиться в умовах компатной температури Tl а другий на-грет до температури Т2. На гарячому кінці пластини кінетична енергія електронов буде більше, ніж у электктронов на холодному кінці. Наслідком ого стану з'явиться процес дифузии електронів з гарячого кінця пластини в більш холодний. Це, у свою чергу, приведе до утворення кінцях пластини нескомпенсированых зарядів: на гарячому кінці позитивного заряду донорів а на холодного-негативного заряду перешедших сюди електронов. Між зарядами виникає різниця потенціалів, називаємая термоелектрорушійною силою,
Якщо нагрівати кінець пластини з електропровідністю р-типа,
єтот кінець зарядиться негативно за рахунок некомпенсованого
заряду акцепторів, а кінець, що ненагрівається - позитивно за рахунок дірок, що перейшли до нього. У цьому випадку знак термо-э. д. с. изме-нится на протилежний у порівнянні з попереднім. Отже, за
знаком термо-э. д. с. можна визначити тип електропровідності по-
лупроводника.
Принципианальная схема методу термозоида представлена на мал.4.20. Напівпровідникова пластина міститься на масивне медноє чи латунну підставу, що служить провідником і теплоот-водом. Зверху на пластину опускають термозоид. Між верхньою і нижньою поверхнями пластини виникає термо-э. д. з, знак до-торою визначають по відхиленню стрілки гальванометра.
Контрольні питання і задачі
1. І чим розходження між електронами провідності і вільними элект-
ронами?
2. Чому питоме сопротипленпе металів росте є ростом температури?
3. При якій умові в металі можуть створюватися куперовские пари?
4. Обчислити швидкість, з яким рухається електрон у мідному провіднику 1 м, коли до нього прикладена різниця потенціалів у 10 В, якщо удель-ное опір міді 1,610~6 Ом-см, а концентрація носіїв 1022 см~3.
5. Чому рухливість електронів більше рухливості дірок?
6. Питомий опір власного германія при кімнатної темпера-
турі р =47 Ом-см, рухливість електронів µп=3900 див2/(З), рухливість
93
дірок = 1900 див2/(З). Знайти концентрацію власних носіїв заряду. Яку потрібно ввести концентрацію донорів, щоб питомий опір напівпровідника знизилося до величини 20 Ом-см?
7. Від чого залежить швидкість генерації носіїв заряду?
8. Чим характеризується стан термодинамічної рівноваги в підлоги
провідниках?
9. Чим визначається концентрація основних носіїв заряду а примесных
напівпровідниках?
10. Чому з ростом температури рівень Ферми у власних напівпро
водниках зміщається убік зони провідності?
11. Концентрація носіїв заряду в n-германії в температурному диапа
зоні від -120 до +30° С постійна, а рухливість електронів змінюється за
законом і. = цо7" . ОБЧИСЛИТИ, У СКІЛЬКОХ разів зміниться електропровідність
германія і цьому діапазоні температур.
12. Як буде змінюватися електропровідність, якщо взяти напівпровідник
"-типу з визначеною концентрацією донорів і вводити усе більша кількість
акцепторів? Накреслити графік залежності електропровідності від концентра
ции акцепторів.
13. Як залежить положення рівня Ферми в примесных напівпровідниках від
концентрації легируючих домішок?
14. У якому випадку в примесных напівпровідниках рівень Ферми оказы
вается в дозволеній зоні?
15. Якими особливостями володіють напівпровідники, у яких може
виникати ефект надпровідності?
16. Як змінюється ширина забороненої зони при зниженні температури?
РОЗДІЛ 5 КІНЕТИЧНІ ЯВИЩА В НАПІВПРОВІДНИКАХ
§ 5.1. ВПЛИВ СИЛЬНИХ ЕЛЕКТРИЧНИХ ПОЛІВ НА ЕЛЕКТРОПРОВІДНІСТЬ НАПІВПРОВІДНИКІВ
При вивченні електропровідності напівпровідників передбачалося, що струм, що проходить через кристал, підкоряється закону Ома:

т. е. концентрація носителея заряду і їхню рухливість не залежать від прикладеної напруги. При впливі сильних електричних полів закон Ома в напівпровідниках порушується. Це може відбуватися по двох причинах. По-перше, швидкість дрейфу носіїв заряду стає порівнянної з тепловою швидкістю, що приводить до зміни рухливості носіїв (ефект розігріву електронного газу й ефект Ганна). По-друге, у сильних полях змінюється концентрація носіїв заряду (ефекти ударної іонізації, термоелектронної іонізації домішок, електростатичної іонізації).
Розглянемо вплив сильного електричного полючи на рухливість носіїв заряду. Слабкі електричні полючи трохи змінюють траєкторію руху електрона, але абсолютна величина його швидкості залишається практично незмінної. З ростом напруженості полючи дрейфова швидкість руху електрона збільшує-
94
ся і поступово стає порівнянної зі швидкістю теплового движення. Швидкість теплового руху визначається тепловий
енергией електрона
 Енергія, що здобувається електроном в
Енергія, що здобувається електроном велектрическом поле, дорівнює е1Е, де 1 - довжина вільного пробігу, Е-напряженность прикладеного полючи. Дорівнюючи ці два вы-ражения, можна знайти напруженість полючи, називану критиче-ской, при якій дрейфова і теплова швидкості стають оди-наковыми

Величина критичної напруженості полючи складає приблизно 104 В/див. Поля, у яких напруженість менше критичного значення, називають слабкими, більше критичного - сильними. Величина критичної напруженості залежить від температури. При розсіюванні носіїв заряду на теплових коливаннях ґрат критична напруженість полючи з ростом температури увеличи-вается. Причина полягає в тім, що з ростом температури зменшується довжина вільного пробігу носіїв заряду, тому для того, щоб носії могли придбати швидкість, велику тепловий, напруженість електричного полючи потрібно збільшувати.
Характер зміни рухливості в сильних електричних полях визначається механізмом розсіювання.
При розсіюванні на теплових коливаннях ґрат, з ростом напруженості полючи вище критичного значення, рухливість носіїв заряду буде залежати від напруженості, зменшуючись з її ростом за законом Е~1/2. Швидкість носіїв заряду визначається енергією. здобува електронами в электричееким поле:

Звідси випливає, що швидкість пропорційна Е1/2, а тому що µ= v/E, те, отже, µ=Е-|/2.
При розсіюванні на іонізованих домішках рухливість носіїв заряду пропорційна третього ступеня швидкості. Оскільки
 рухливість пропорційна напруженості в ступені
рухливість пропорційна напруженості в ступені 
З ростом напруженості полючи вище критичного значення, при розсіюванні носіїв заряду на іонізованих домішках, рухливість носіїв зростає,
В області низьких температур у сильних електричних полях діють обидва механізми розсіювання, і графік залежності рухливості носіїв заряду від напруженості прикладеного електричного полючи має вид, показаний на мал. 5.1. Спочатку, до величини Екр, рухливість носіїв заряду не змінюється, потім починає рости - носії розсіюються на іонізованих домішках - і зростає доти , поки переважним не немає механізм розсіювання на теплових коливаннях ґрат.
Якщо розглядати залежність рухливості носіїв від напруженості полючи в області високих температур, то після дости-
95
жения напруженістю критичного значення, рухливість носіїв заряду відразу починає падати (мал. 5.2).
Експериментально встановлене, що зміна електропровідності відбувається в основному не за рахунок зміни рухливості, а через зміну концентрації носіїв.
Зупинимося на ефектах, що приводять до збільшення концентрації носіїв. Зі зростанням напруженості електричного полючи починає діяти механізм термоелектронної іонізації домішок. Прикладене до кристала електричне поле змінює енергетичні стани електронів в атомі. Унаслідок цього енергія, яку потрібно затратити для пс,.переходу електрона у вільний стан, зменшується, а імовірності переходу електронів у цей стан збільшується, що приводить до зростання кін-
 центрации носіїв заряду. Цей механізм порушення носіїв звичайно обумовлений донорной домішкою і лише в тому випадку, коли концентрація ненонизированной домішки значно перевищує концентрацію рухливих електронів. Термоелектронна іонізація протікає при напряженностях полючи порядку 103- 104 В/див.
центрации носіїв заряду. Цей механізм порушення носіїв звичайно обумовлений донорной домішкою і лише в тому випадку, коли концентрація ненонизированной домішки значно перевищує концентрацію рухливих електронів. Термоелектронна іонізація протікає при напряженностях полючи порядку 103- 104 В/див.Ефект термоелектронної іонізації залежить від температури. З підвищенням температури ступінь іонізації домішок зростає і вплив термоелектронної іонізації зменшується. Проявом ефекту термоелектронної іонізації служить, тунельне проходження електронів із примесных рівнів у зону провідності, що відбуває в тому випадку, якщо електрони не володіють достатньою тепловою енергією, необхідної для подолання потенційного бар'єра. Тунельне проходження електронів спостерігається при значеннях напруженості полючи порядку 106 В/див.
Ефект ударної іонізації починає виявлятися при напря-жннгостях полючи порядку 104-106 В/див. Сутність цього ефекту полягає в тім, що під дією електричного полючи рухливі електрони можуть придбати енергію, достатню для вибивання електронів з ковалентного зв'язку ґрат, Що Збуджує
96
електрон залишається рухливим. Електрони, що утворилися, також беруть участь у процесі порушення, у результаті йде лавинообразное наростання концентрації носіїв заряду. У залежності від напруженості полючи ударна іонізація може протікати по-різному. У полях невеликої напруженості на довжині вільного пробігу електрон здобуває лише частина енергії, необхідної для іонізації. Якщо при зіткненнях з чи фононами іншими носіями заряду електрон утрачає невелику частину своєї енергії, то поступово швидкість його буде зростати, і в підсумку стане

достатньої для іонізації атомів напівпровідника. У полях високої напруженості електрону для порушення досить енергії, придбаної на довжині вільного про-бігу.У дуже сильних електричних полях може відбуватися електростатична іонізація, називана інакше ефектом Зенера. У таких полях стає ймовірним тунель-ніс просочування носіїв заряду через заборонену зону. Перехід електронів виявляється можливим унаслідок того, що сильне зовнішнє поле викликає нахил енергетичних зон, тим більший, ніж більше напруженість прикладеного полючи. Перехід електронів з валентної зони в зону провідності можливий, як показано па мал. 5.3, по АБ і АВ.Перехід АБ вимагає витрати енергії Еаб ,а при переході АВ енергія електрона не змінюється: Ел-Ев. Перехід АВ і є тунельний. Імовірність тунельного проходження тим більше, чим менше ширина енергетичного бар'єра, умовно обумовлена величиною відстані АВ. Це відстань тим менше, чим більше напруженість полючи, тому що сильніше нахил зон. Тунельний ефект виявляється при напруженості полючи порядку 107 В/див.
§ 5.2. ЕФЕКТ ГАННА
До ефектів сильного нуля відноситься ефект Ганна, відкритий у 1963 р. Сутність цього ефекту полягає в наступному. Якщо до зразка напівпровідника прикласти електричне поле з напруженістю, більшої деякого граничного значення, то в такому зразку можуть виникнути високочастотні коливання електричного струму. Вперше ефект Ганна спостерігалася на зразках з ар-сенида галію Ga.s і фосфіду індію Іпр n-типу. Для GaAs граничне значення напруженості полючи складає близько 3 кв/див, для Іпр - близько 6 кв/див. Характерною рисою цих і інших напівпровідників, у яких може виникнути ефект Ганна, є складна структура зони провідності (мал. 5.4). У зоні провідності маються дві долини, розділені потенційним бар'єром ?Е. Електрони в цих долинах мають різну ефективну масу, а отже, і різну рухливість. У нижньої
4-56 97
долині знаходяться легкі електрони, у верхньої - важкі. При кімнатній температурі і малих значеннях напруженості полючи практично вага електрони знаходяться в нижній долині.
Якщо концентрація електронів у зразку дорівнює п, у нижній долині п1, а у верхньої n2, то при додатку слабкого електричного полючи Е1 електропровідність зразка буде визначатися концентрацією n1

де - рухливість електронів у нижній долині, v1 - швидкість

електронів при напруженості полючи Е\.
Оскільки п1 = п, те = enµ.
Зі збільшенням напруженості полючи до Е2 енергія електронів починає зростати, частина їх переходить у верхню долину, і в електропровідності беруть участь електрони верхньої долини. Електропровідність зразка

Де µ 2 - рухливість електронів у верхній долині.
Порівнюючи приведені вираження для v2, знайдемо
На підставі рівності п = п-п

Середня швидкість визначається под-вижностями електронів в обох долинах, а тому що n1+n2=п, те можна записати

Звідси випливає, що середня швидкість електронів з переходом їхній у верхню долину знижується, і тем сильніше, чим більше там стає концентрація електронів п2.
Величина струму, що проходить через зразок, визначається середньою швидкістю руху електронів, тому падіння швидкості приведе до уповільнення росту струму. На мал. 5.5 представлена залежність струму, що проходить через зразок, від величини прикладеної напруги. При малих значеннях напруженості полючи до Е1-, залежність між струмом і напругою линейна. Коли починається зменшення середньої швидкості електронів за рахунок переходу деякої їхньої кількості у верхню долину, залежність стано-
98
вится нелінійної (ділянка АВ), Нарешті, при досягненні граничного значення напруженості всі електрони нижньої долини одержать необхідну енергію для подолання потенційного бар'єра ?Е, і почнуть переходити у верхню долину. Електропровідність зразка буде визначатися вираженням

а дрейфова швидкість різко зменшиться. Це буде відповідати ділянці ВР, називаному ділянкою негативного дифференци-ального опору. Подальше збільшення напруженості пиляючи приведе до наростання швидкості важких електронів (учас-ток СD).
Розглянемо докладніше процес переходу електронів у верхню долину на прикладі зразка напівпровідника, що представляє з-

бій прямокутну пластину, на торцях якої нанесені метал-лические контакти (мал. 5.6). Один контакт служить анодом, дру-гой - катодом.
Прикладене між контактами напруга повинна распреде-ляться рівномірно по всьому обсязі пластини. Якщо ж у зразку утішний якась неоднорідність, що володіє підвищеним сопро-тивлением, то в цій частині зразка напруженість полючи буде мати більш високе значення в порівнянні з напруженістю в іншому обсязі. Зі збільшенням прикладеної напруги гранична напруженість полючи тут буде досягнута раніш, ніж в іншому обсязі зразка. Перехід електронів цієї ділянки у верхню долину приведе до ще більшого наростання напруженості полючи. 1.1 іншому обсязі зразка напруженість нуля буде соответст-венно знижуватися.
В області неоднорідності утвориться зона важких електронів, що під дією прикладеного полючи буде перемішатися до анода. Ліворуч і праворуч від зтой області будуть рухатися легкі элек-троны. Праворуч легкі електрони будуть іти від області важких електронів, тому тут утвориться надлишковий позитивний заряд (мал. 5.7). Ліворуч від області важких електронів будуть
99
накопичуватися легкі електрони, утворити надлишковий отрицатель-
ный заряд.
Область, де діють позитивні і негативні заряди, називають електричним доменом. Напруженість електричного полючи усередині домена велика, тому швидкість руху електронів тут починає зростати. Поза домена швидкість руху електронів зменшується. Через якийсь час установлюється рівноважний стан, при якому швидкості руху електронів усередині і поза областю домена стають однаковими.
Утворення домена в кристалі відповідає різкому зростанню питомого опору. У випадку додатка до кристала електричного полючи з критичним значенням напруженості утворення домена приводить до зменшення струму, що проходить

через зразок. Процес утворення домена дуже короткочасний, тому можна вважати, що струм практично миттєво переходить від максимального значення до мінімального. Поки домен рухається до анода, величина струму залишається незмінної. Досягши анода, домен починає руйнуватися, а струм - зростати. Як тільки домен зруйнується і струм досягне максимального значення, утвориться новий домен, і струм миттєво спадає до мінімуму. Далі всі процеси повторюються знову (мал. 5.8).Новий домен може виникнути на будь-якій іншій неоднорідності, але в кристалі завжди може існувати тільки один домен. Щоб частота зміни струму залишалася незмінної, необхідно, щоб утворення домена відбувалося на одній і тій же неоднорідності. Це досягається технологічним шляхом при виготовленні електродів. У процесі легування кристалів створюють неоднорідність в області катода, тому частота коливань визначається часом руху домена від катода до анода, що, у свою чергу, залежить від довжини зразка між електродами.
В даний час на основі ефекту Ганна розроблені діоди Ганна, здатні працювати на частотах від часток герца до сотень гигагерц. За певних умов діод Ганна може працювати в режимі обмеженого нагромадження об'ємного заряду (ОНОЗ). Максимальна частота коливань в ОНОЗ теоретично може досягати тисячі гигагерц. У діоді Ганна спостерігають світлове випромінювання, лазерний ефект, модуляцію світлового потоку доменом
100
генерацію могутніх ультразвукових коливань. Діоди Ганна з нанесеними на їхню поверхню діелектричними чи напівпровідниковими плівками можуть бути використані для створення опто-электронных чи акустоэлектронных приладів.
§ S.3. НЕРІВНОВАГІ НОСІЇ ЗАРЯДУ
У напівпровіднику під дією зовнішніх факторів концентрація носіїв заряду може істотно змінюватися. Раніше вже згадувалося, що в напівпровіднику, що знаходиться в стані термодинамічної рівноваги, швидкості теплової генерації і рекомбінації взаємно врівноважуються, тому в ньому установлюється визначена рівноважна концентрація носіїв заряду. При наявності зовнішніх впливів (місцеве нагрівання, висвітлення, зовнішнє поле і т.д. ) може відбуватися генерація носіїв заряду, що приводить до появи надлишкової, чи нерівновагої, концентрації. Збільшення концентрації носіїв заряду відповідно викликає зростання швидкості рекомбінації. Час існування нерівновагих носіїв заряду, тобто середній час між генерацією і рекомбінацією нерівновагих носіїв зарядів в обсязі напівпровідника, називають об'ємним часом життя нерівновагих носіїв т.
У примесных напівпровідниках у більшості випадків концентрація нерівновагих носіїв заряду набагато менше концентрації рівноважних основних носіїв, але може бути порівнянна і навіть більше, ніж концентрація неосновних носіїв.
Час життя носіїв заряду не є постійним параметром напівпровідника, тому що воно залежить від концентрації нерівновагих носіїв заряду, температури, концентрації домішок і дефектів ґрати. Середній час життя носіїв заряду в напівпровіднику складає 10-2-10~8 с.Якщо процес генерації нерівновагих носіїв заряду відбувається не у всьому обсязі, а тільки в якійсь частині напівпровідника, то там утвориться локальна область з підвищеною концентрацією носіїв заряду, що викликає появу дифузійного струму. Величина цього струму буде тим більше, чим більше концентрація нерівновагих носіїв заряду.Процес дифузії носіїв одного знака супроводжується в однородно легованих напівпровідниках дифузією носіїв заряду іншого знака. Припустимо, що частина дірок пішла з даного обсягу напівпровідника. У результаті порушилася электро-нейтральность цього обсягу, утворився просторовий заряд і виникло електричне поле. Поле викликає поява потоку електронів, що цілком відновлять электронейтральность і зразку, причому відбудеться це практично миттєво.У процесі дифузії нерівновагі носії заряду рекомби-нируют. За час життя нерівновагі носії проходять деякий середній шлях, називаний дифузійною довжиною неосновних носіїв заряду L. Цю довжину визначають як відстань, на до-
101
тором концентрація надлишкових носіїв унаслідок рекомбінації зменшується в е раз. Дифузійна довжина і час життя зв'язані між собою співвідношенням
 у який D - коэффициент дифузії носіїв заряду.
у який D - коэффициент дифузії носіїв заряду.§ 5.Л. НЕОДНОРІДНІ НАПІВПРОВІДНИКИ. ДИФУЗІЙНІ І ДРЕЙФОВІ СТРУМИ
У напівпровідниковій техніці для виготовлення напівпровідникових приладів часто використовують неоднорідні напівпровідники, одержувані в результаті нерівномірного легування напівпровідникових пластин домішками.

У неоднорідних напівпровідниках через нерівномірність розподілу концентрації домішок і носіїв заряду по кристалі рівень Ферми розташовується на неоднаковій відстані від границь дозволених зон. В області, де значення концентрації носієм більше, рівень Ферми наближається до дозволеної зони, а в області з меншою концентрацією віддаляється до середини запитаної зони.
На мал. 5.9, а приведена схема напівпровідника з електропровідністю р-типа з нерівномірною концентрацією акцепторів, а на мал. 5.9, б - зонна діаграма напівпровідника, що відповідає такому розподілу принесений.
У цьому напівпровіднику дифузія носіїв заряду походить з області з більшою їхньою концентрацією в область з меншою концентрацією. Дифузія носіїв заряду приводить до того, що в області з більшою концентрацією залишається некомпенсований заряд іонізованих атомів домішки, а протилежна частина напівпровідника заряджається надлишковими носіями, що перейшли сюди, заряду (мал. 5.10, а).
102
Між зарядами негативних акцепторів і позитивних дірок утвориться різниця потенціалів U, під дією якої в напівпровіднику протікає дрейфовий струм дірок, спрямований назустріч дифузійному струму дірок. В міру дифузії градієнт концентрації носіїв заряду зменшується, а дрейфовий струм через ріст об'ємних зарядів буде рости. Рівновага наступить тоді, коли дрейфовий струм досягне величины дифузійного струму. У стані термодинамічної рівноваги енергія рівня Ферми однакова по всьому кристалі, і границі енергетичних зон виявляються зміщеними стосовно рівня Ферми (мал. 5.10, б). Величина нахилу границь зон характеризує напруженість електричного полючи, що возникли в кристалі. Чим більше градієнт концентрації домішки, тим вище напруженість полючи, що виникає в напівпровіднику і тем більше нахил енергетичних зон.
Дифузійний струм залежить від величини градієнта концентрації носіїв заряду:

де Dp - коефіцієнт дифузії дірок; dpjdx - градієнт концентрації дірок.
Дрейфовий струм Jдр визначається величиною градієнта потенціалу електричного полючи, рівного величині напруженості електричного поли Е, що, у свою чергу, тим більше, чим більше градієнт концентрації носіїв заряду:

Продифференцируем отримане вираження і підставимо його в рівняння для стану рівноваги:

103
Звідси коефіцієнт дифузії дірок

Аналогічно цьому коефіцієнт дифузії електронів

Отримані вираження називають співвідношеннями Эйнштейна. Вони показують істотну залежність коефіцієнта дифузії від температури.
§ 5.5. ВИМІР ПАРАМЕТРІВ НАПІВПРОВІДНИКІВ
Вимір рухливості носіїв заряду. Рухливість поси-телей заряду вимірюють шляхом реєстрації дрейфу нерівновагих носіїв в електричному полі. Для цей зразок напівпровідника прямокутної форми, на торцях якого створені металеві контакти, поміщають в електричне поле. На зразку встановлюють два вольфрамових зонди на деякій відстані І
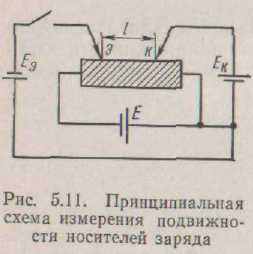
друг від друга (мал. 5.11). Один із зондів служить эмиттером, іншої - колектором. Через эмиттерный зонд від джерела Еэ в зразок уводяться носії заряду, що переміщаються під дією електричного полючи, створюваного джерелом Е, до колекторного зонда. На колектор подасться зворотна напруга від джерела постійного струму Ек, тому через колектор проходить невеликий струм неосновних носіїв. Як тільки введені носії досягнуть колекторного зонда, струм у ланцюзі колектора зросте.
Вимірюючи час tдр руху носіїв заряду між эмиттерным і колекторним зондами і знаючи довжину /, можна визначити величину дрейфової швидкості v = 1/tдр, і по ній розрахувати величину рухливості:

Структурна схема установки приведена на мал. 5.12. Напруга з Rн подається на осциллограф (МО), через диференціальний підсилювач (У). На екрані осциллографа можна спостерігати імпульси колекторного струму і по мітках часу визначити час дрейфу носіїв заряду від эмиттерного зонда до колекторного. За допомогою генератора Г2 у зразку створюється так називане електричне поле, що тягне, за допомогою імпульсів прямокутної форми. У момент часу t1 у зразок напівпровідника від генератора Г через эмиттерный зонд за допомогою прямокутного импуль-
104
са токи вводяться нерівновагі носії заряду, що під дією електричного полючи почнуть дрейфувати до колектора. Через якийсь час ці носії досягнуть колектора, струм

колектора зросте, що буде зареєстроване осциллографом. У момент часу t2 імпульс струму від генератора Г1 припиниться, але носії ще будуть продовжувати дрейфувати до колектора. У момент часу t останні носите-

чи досягнуть колектора і струм колектора зменшиться, що буде також зафіксоване осциллографом. Час між цими двома імпульсами, лічений з екрана осциллографа, буде часом дрейфу (мал. 5.13). Відстань між зондами визначають за допомогою мікроскопа.
Вимір часу життя носіїв заряду. Одним з методів виміру часу життя неосновних носіїв заряду є метод модуляції електропровідності. Сутність цього методу полягає в наступному. Якщо в зразок напівпровідника за допомогою металевого зонда инжектировать носії заряду, опір напівпровідника зменшується. При припиненні інжекції введені нерівновагі носії будуть рекомбинировать і опір полупроводника почне відновлюватися. Через деякий проміжок часу воно стане рівним первісному значенню. Якщо зробити повторну інжекцію, коли ще не всі носії заряду встигнуть рекомбинировать, то опір напівпровідника для другого імпульсу буде менше - у цьому складається процес модуляції електропровідності.
Практично інжекцію носіїв заряду здійснюють за допомогою прямокутних імпульсів струму. На зразок подаються два
105
імпульсу: перший - инжектирующий, а через якийсь час, називане часом затримки t3 другий - вимірювальний (мал. 5.14). Спадання напруги на зразку в момент подачі вимірювального імпульсу визначається величиною опору зразка, що, у свою чергу, залежить від часу затримки подачі другого імпульсу. Змінюючи час затримки між імпульсами, можна визначити закон зміни опору зразка по величині початкового спадання напруги на зразку {мал. 5.15).

Огибающая цих імпульсів характеризує закон зміни опору напівпровідника в залежності від часу затримки між імпульсами. Різниця напруг на зразку змінюється экспоненциально в часі:

де А - коефіцієнт пропорційності.
Якщо побудувати графік залежності 1п(U1-U2) від часу затримки t3 (мал. 5.16), то по нахилі прямої можна визначити час життя носіїв заряду:

Структурна схема вимірювальної установки представлена на мал. 5.17. Прямокутний імпульс струму від генератора Г, пропускається через зразок; одночасно сигнал від генератора Г1 надходить на лінію затримки ЛЗ. За допомогою лінії затримки встановлюється необхідний час затримки t3 між инжектирующим імпульсом від Г1 і вимірювальним імпульсом від Г2.
Напруга зі зразка подається на обмежник імпульсів ОГР, тому що величина імпульсів напруги, що виникають на зразку, значно перевищує зміну напруги, вызван-ное модуляцією провідності зразка; з обмежника імпульсів напруга подається на осциллограф ОСЦ.
106
Вимір дифузійної довжини. Визначення дифузійної довжини неосновних носіїв заряду засновано на вимірі просторового розподілу концентрації нерівновагих носите-

лий заряду, збуджених світлом. Цей метод виміру називають методом нерухомого світлового зонда; під дією світла в напівпровіднику ВІДБУВАЄТЬСЯ генерація нерівновагих носіїв

заряду. Концентрація нерівновагих носіїв заряду максимальна в центрі освітленої області і поступово спадає в міру видалення від її (мал. 5.18). До поверхні кристала притискається металевий зонд (детектор), на який подається невелике
107
напруга. Тік через контакт метал - напівпровідник залежить від концентрації нерівновагих носіїв заряду, тому при різних відстанях х між світловим зондом і детектором струм через детектор міняється. Принципова схема установки представлена на мал. 5.19.
Пучок світла від лампи 2 з вольфрамовою ниткою розжарення стрічкового типу фокусируется дзеркалом 1 через вузьку щілину 3. Зображення щілини проектується на досліджувану поверхню лінзою 6, положення якої регулюється. Тубус, у якому знаходиться лінза, постачений усередині екранами, що запобігають улучення

розсіяного світла на зразок о. Між щілиною і лінзою розташований модулятор світла у виді диска 4 із прорізами, насадженого на вісь синхронного двигуна 5. Застосування модульованого світла дозволяє вимірити тільки ту частину зворотного струму, що пропорційна концентрації нерівновагих носіїв заряду. Модулятор дає практично прямокутні імпульси світла. Частота модуляції складає порядку 100 Гц.
Детектор 7 закріплюється в мікроманіпуляторі, що дозволяє точно установити його на поверхні кристала. Зонд підходить до поверхні кристала під кутом 10-30° щодо вертикальної осі, щоб не відкидати тінь на освітлювану площу.
Вимір дифузійної довжини зводиться до встановлення залежності спадання напруги U на резисторі R, включеному послідовно з детектором, від відстані між світловим зондом і детектором. Для цей кристал з детектором переміщають щодо нерухомої оптичної системи, що рівносильно руху світла щодо детектора. У центрі світлового зонда вимірювана напруга повинна бути максимальним і зменшуватися в міру видалення зонда від світлової плями (див. мал. 5.18).
Відстань між світловим зондом і детектором варто збільшувати доти , поки вимірювана напруга не стане порівнянним з напругою чи шуму світловий зонд виявиться близько розташованим до торців зразка. Напруга, вимірювана селективним ламповим вольтметром 10. пропорційно концентрації нерівновагих носіїв заряду:
Для збільшення корисного сигналу, зниження рівня шумів і забезпечення стабільності роботи в установці передбачена робота в режимі формування імпульсами струму контакту метал - напівпровідник за допомогою спеціального блоку формування 11. Переміщення зразка здійснюється автоматичним пристроєм 9.
За отриманим значенням напруги будують графік залежності 1 n V від х, і по цьому графіку визначають дифузійну
108
§ 5.6. ГАЛЬВАНОМАГНІТНІ ЕФЕКТИ
довжину як котангенс кута нахилу отриманої прямої (мал. 5.20):


Якщо напівпровідник, по якому проходить струм, помістити в магнітне поле, то в напівпровіднику виникає ряд ефектів, називаних гальваномагнітними. До них відносяться ефект Холу, поперечний і подовжній термогальваномагнітні ефекти й ефект зміни електричного опір напівпровідника. Далі пре-водиться опис різних ефектів. Ефект Холу. Цей ефект був відкритий Е. Холом у 1879 р. Сутність явища полягає в наступному. Якщо напівпровідникову пластину, по якій проходить струм, помістити в магнітне поле, спрямоване перпендикулярно лініям струму (мал. 5.21), го в ній виникне різниця потенціалів у напрямку, перпендикулярному току імагнітному полі. В основі цього ефекту лежить взаємодія між
електричними зарядами і магнитны-
мі полями. Будь-яка заряджена частка, що рухається в магнітному нулі, випробує вплив сили Лоренца, напрямок якої перпендикулярно напрямку руху частки і напрямку магнітного полючи.
Величина цієї сили прямо пропорційна величині заряду, швидкості частки і магнітної індукції В:

Відхилення електронів продовжується доти , поки сили магнітного

\полючи й електричного полючи взаємно не зрівноважаться:

109
Напрямок дії сили Лоренца визначається правилом лівої руки. Під дією цієї сили електрони будуть відтискуватися до однієї сторони пластини, заряджаючи її негативно, а протилежна сторона зарядиться позитивно. Поперек пластини виникає різниця потенціалів Ux і електричне поле, що перешкоджає поділу зарядів під дією сили магнітного полючи. Величина сили електричного полючи визначається напруженістю полючи:

З цієї рівності можна визначити величину різниці потенціалів:

Щільність минаючого через кристал струмутой же час J=env.
Звідси швидкість руху електронів

Отримане вираження для швидкості підставляємо у вираження для Uх:

У частково компенсованих і власних напівпровідниках в електропровідності беруть участь і електрони, і дірки. Позначимо 1/(en)=Rx, де Rx - постійна Холу. Тоді
 [Магнітне поле відхиляє їх до однієї сторони пластини. Э.д.с. Холу в
[Магнітне поле відхиляє їх до однієї сторони пластини. Э.д.с. Холу в цьому випадку виникає тільки за умови, якщо електрони і дірки мають різні рухливості. Величина э.д.с. Холу для Власних напівпровідників і напівпровідників, електропровідность у який здійснюється електронами і дірками, значительно менше, ніж для напівпровідників з одним видом носіїв
заряду. Постійна Холу для напівпровідників з носіями зарядуобох знаків: Для власних напівпровідників, у яких п = р = п1лТаким чином, э.д.с. Холу залежить від величини минаючого струму, напруженості магнітного полючи, товщини пластини і концентрації носіїв заряду. Залежність від концентрації говорить про те, що в металах э.д.с. Холу в порівнянні з напівпровідниками набагато менше, і саме тому практичне використання ефекту Холу почалося тільки з застосуванням напівпровідників.Якщо носіями заряду є дірки, то заряди на сторонах пластини поміняються місцями і э.д.с. Холу змінить знак. Ефект Холу тому використовують для визначення типу електропровідності напівпровідника. Умовно прийнято вважати, що знак э.д.с. Холу відноситься до постійного Холу Rх. В електронних напівпровідників постійна Холу негативна:

У дырочных позитивна:

При висновку формули для V-n ми думали, що всі носії заряду мають однакову швидкість руху. Якщо враховувати розподіл носіїв заряду по швидкостях і брати усереднене значення швидкості, то необхідно ввести числовий множник відмінний від одиниці:

де А - постійна, залежна від механізму розсіювання носіїв заряду; А= 1,93 - 0,99.
110
За допомогою ефекту Холу вивчають властивості полупроводнико-вых матеріалів. На підставі постійної Холу розраховують концентрацію носіїв заряду. Вимірюючи постійну Холу в деякій області температур, можна одержати температурну за-висимость концентрації носіїв заряду і по цій залежності визначити концентрацію домішок і енергію їхньої активації.
Одночасний вимір постійної Холу і питомого опору напівпровідника дозволяє розраховувати так назы-ваэмою "холловскую" рухливість носіїв заряду. Тому що

Ефект Холу знаходить широке практичне застосування. На його основі створені напівпровідникові датчики Холу, за допомогою яких можна вимірювати напруженість магнітного полючи, величи-ну струму й електричної потужності.

За допомогою ефекту Холу можна генерувати, модулювати і демодулировать электриче-ские коливання, підсилювати електричні сигнали. Поперечний термогальваномагнітний ефект. При висновку фор-мули для напруги Холу було прийнято, що електрони в
 напівпровідниковій пластині рухаються з однаковою середньою швидкістю. \\ дійсності теплові швидкості руху носіїв заряду різні. Це означає, що магнітне поле діє на електрони з різною силою, оскільки сила Лоренца залежить від скоро-сти (FM-=CVB).
напівпровідниковій пластині рухаються з однаковою середньою швидкістю. \\ дійсності теплові швидкості руху носіїв заряду різні. Це означає, що магнітне поле діє на електрони з різною силою, оскільки сила Лоренца залежить від скоро-сти (FM-=CVB).Чим більше швидкість електронів, тим більше сила Лоренца, тому швидкі електрони відхиляються магнітним полем сильніше. Крім того, більш рухливі носії переносять і велику теплову енергію. Щоб увійти з іншими носіями в рівноважний стан, ці електрони віддають свою надлишкову енергію ґратам. У результаті буде нагріватися та сторона пластини, до якої відхиляються швидкі електрони.
111
Більш повільні електрони, для яких сила електричного полючи більше сили магнітного полючи, будуть підходити ближче до іншої сторони пластини і відбирати відсутню енергію в ґрат, що приведе до охолодження цієї частини пластини. Отже, у пластині виникне перепад температур. Виникнення поперечного градієнта температур у напівпровіднику внаслідок розкиду швидкостей носіїв при протіканні електричного струму в напівпровіднику і при впливі поперечного магнітного полючи називають поперечним термогальваномагнітним ефектом. Цей ефект уперше спостерігав німецький фізик Л. Эттингсгаузен у 1887 р. Величина ефекту міняється прямо пропорційно силі струму і величині напруженості нуля і назад пропорційно товщині пластини.
Як і ефект Холу, поперечний термогальваномагнітний ефект у металах виявляється слабко. Наприклад, при товщині мідної пластини приблизно 0,025 мм, струмі в 1 А, магнітної індукції 1,2 Тл, Uх = 0,24 мкв перепад температури складає всего 0,000075 ДО. Практично цей ефект у напівпровідниках можна використовувати для холодильних установок.
Магниторезистивный ефект. Магнітне поле викривляє траєкторію руху електронів, "закручуючи" їх по круговій орбіті тим сильніше, чим більше напруженість полючи. Вплив магнітного полючи па рух електронів приводить до зміни електропровідності напівпровідника, тобто до зміни його опору. Зміна електричного опору напівпровідника під дією магнітного полючи називають магниторезистивным ефектом. Сутність ефекту полягає в наступному. Наявність розподілу електронів по швидкостях обумовлює процес поділу їхньої траєкторій під дією електричних і магнітних полів. Прямолінійні траєкторії мають електрони, що рухаються із середньою дрейфовою швидкістю. Між зіткненнями вони проходять шлях, дорівнює довжині вільного пробігу І. Носії заряду, що рухаються зі швидкістю, меншої середній, відхиляються електричним полем, а зі швидкістю, більшої середній - магнітним полем, у протилежну сторону. В обох випадках довжина вільного пробігу носіїв заряду в напрямку електричного полючи зменшується. Рухливість носіїв заряду визначається відстанню, пройденим у напрямку електричного полючи, і зменшення рухливості знижує електропровідність напівпровідника.
Ефект Нернста. Розподіл електронів по енергіях приводить ще до одного ефекту - подовжньому термогальваномагнит-ному, чи ефекту Нернста. Сутність його полягає у виникненні подовжнього градієнта температури в напівпровіднику внаслідок розкиду швидкостей носіїв заряду при проходженні через напівпровідника електричного струму і при впливі поперечного магнітного полючи.
Магнітне поле в різному ступені викривляє траєкторію руху більш повільних і більш швидких електронів, тому електрони, що володіють великою енергією, проходять через кри-
112
сталл, майже не змінюючи своєї траєкторії, а електрони з меншою енергією утримуються в однієї сторони кристала. Швидкі електрони віддають свою надлишкову енергію кристалічним ґратам, а повільні, навпаки, поповнюють свою енергію за рахунок ґрат. Це приводить до появи подовжньої різниці температур.
§ 5.7. ТЕРМОМАГНІТНІ ЕФЕКТИ
До термомагнітного відносяться ефекти, що спостерігаються в підлог-провідниках, що володіють градієнтом температури при впливі па їх магнітного полючи; це термогальваномагнітний і тер-момагнитный ефекти.
Термогальваномагнітний ефект. У 1886 р., вивчаючи ефект Холу, Эттингегаузеи і Нернст замінили електричний струм тепловим потоком і знайшли, що при цьому з'явилася різниць-потенціалів у напрямку, перпендикулярному напрямкам магнітного полючи і теплового потоку. Величина цієї різниці потенціалів мінялася пропорційно напруженості магнітного полючи, величині градієнта температури уздовж зразка і його ширині. Виникнення поперечної напруженості електричного полючи в напівпровіднику внаслідок наявності подовжнього градієнта температури і поперечного магнітного полючи називають термогальваномагнітним ефектом.
Термомагнітний ефект. У 1887 р. незалежно друг від друга італієць А. Риги і француз С. Ледюк знайшли, що термогаль-ваномагнитный ефект супроводжується термомагнітним ефектом- виникненням поперечного градієнта температур у напівпровіднику при наявності подовжнього градієнта темпера-тyp і впливі поперечного магнітного полючи. Величина поперечного градієнта температур прямо пропорційна напруженості магнітного полючи, подовжньому градієнту температури і ширині пластини.
Виникнення різниці температур аналогічно виникненню э.д.с. Холу, тому що тепловий потік - це таке ж, як і електричний струм, спрямоване рух електронів. У тепловому потоці існує статистичний розподіл електронів по енергіях, а виходить, і по швидкостях, що і є причиною утворення поперечного градієнта температури.
§ 5.8. ТЕПЛОВІ ВЛАСТИВОСТІ НАПІВПРОВІДНИКІВ
Внутрішня енергія твердого тіла складається з кинетиче-і кін енергії коливних атомів і потенційної енергії їх

Теплоємність. Теплоємність - це зміна внутрішньої енергії тіла при зміні його температури на один градус при по-стояннном обсязі тіла:
113
взаємодії, середні значення кінетичної і потенційної енергій коливної частки однакові і рівні 3/2 до Т, звідси повна енергія частки E = 3k. Повна енергія грам-атома будь-якої речовини - Ег-а = ЕNА Тут NA = Ro/k - число Авогадро, Ro- універсальна газова постійна. Енергія грам-атома буде дорівнює
 Роблячи диференціювання енергії по температурі, знаходимо вираження для теплоємності: C=3R0. Це співвідношення називають законом Дюлонга - Пти. З нього випливає, що теплоємність
Роблячи диференціювання енергії по температурі, знаходимо вираження для теплоємності: C=3R0. Це співвідношення називають законом Дюлонга - Пти. З нього випливає, що теплоємність
усіх тіл повинна бути однакова і дорівнює приблизно 25 Дж/(моль- ДО) чи 6 кал/(град-моль-град). Однак експериментальні дані показують, що теплоємність твердих тіл не є величиною постійної, а зменшується зі спадом температури (мал. 5.22), починаючи з деякого значення температури. Цю критичну крапку називають температурою Дебая і позначають В. Температурна залежність теплоємності була вперше пояснена Эйнштейном, що припустив, що енергія коливного атома квантована, тобто змінюється не безупинно, а визначеними пір-
циями- квантами: E = hv.Спектр коливного атома складається із серії ліній, що відстають одна від іншої на рівну відстань E = hv. Мінімальне значення енергії атомів відповідає температурі абсолютного нуля.
Раніше згадувалося, що і при абсолютному нулі атоми твердого тіла знаходяться в особливому стані руху - нульовому русі. Особливість цього руху полягає у відсутності дискретних характеристик і відсутності фононів при абсолютному нулі температури.
Мінімальна довжина хвилі коливань, можлива в кристалі, = 2а, де а - постійна ґрати. Звідси максимально можлива частота коливань атомів дорівнює відношенню швидкості звуку в кристалі до мінімальної довжини хвилі коливань:

Цій частоті відповідає енергія з = 0,1 ев.
Для пояснення залежності теплоємності від температури розглянемо тверде тіло, що знаходиться в рівновазі з навколишнім середовищем при температурі 100 ДО. Середня кінетична енергія атомів газу навколишнього середовища при цій температурі дорівнює

= 0,01 ев, що набагато менше, ніж Е. Це означає, що атоми газу не в змозі перевести атоми твердого тіла в збуджене
114
стан. Однак через статистичний розподіл часток по енергіях, деякі атоми газу виявляються здатнимипереклад атомів твердого тіла в збуджений стан. Теплоємність тіла завдяки цьому стає відмінної від нулі, але досягти максимального значення не може. Це відбудеться при збільшенні температури газу, коли енергія всіх атомів газу досягне значення Е и всі атоми твердого тіла перейдуть у відданий стан.
Такий перехід відбувається при
 називаною температурою
називаною температуроюДебая. Величину Q знаходять зі співвідношення:

де V max - максимальна частота теплових коливань атомів, характерна для даного кристала. температура Дебая визначається енергією зв'язку між частками твердого тіла. При значеннях температури, що перевищують дебаевскую, у кристалі можуть збуджуватися коливання з будь-яким"південними для даного твердого тіла частотами, тому квантовий характер теплових волі не буде виявлятися і теплоємність не буде залежати від температури.
Теплопровідність. Теплопровідністю називають властивість твepдых тіл переносити тепло від більш нагрітих частин тіла до менш
нагретым., що приводить до вирівнювання температури. Вона характеризується коефіцієнтом теплопровідності, чисельно рівним кількості теплової енергії, що проходить у 1 з через перетин зразка
в 1 м , при градієнті температури в 1 ДО/м. У твердих тілах перініс тепла здійснюється різними механізмами, основними зпых є перенос тепла фонон-фононна чи решеточная теплопровідність, і електронами провідніст-електронна теплопровідність. У чистих металах теплопровідністьздійснюються електронами. У сильно забруднених металах інеупорядкованих сплавах у теплопровідності беруть участь фонони.діелектриків, що практично не містять вільних спостерігається решеточная теплопровідність. напівпровідниках сполучаються обоє основних механізму теплопровідності. У залежності від кристалічної структури, природи хімічного зв'язку, температури й інших факторів у напівпровідниках переважає той чи інший механізм теплопровідності.
Коефіцієнт теплопровідності твердого тіла виражається Сум який коефіцієнтів різних механізмів теплопровідності:

де х -електронна теплопровідність, хр - решеточная теплопровідність.
Розглянемо обидва механізми переносу тепла у твердому тілі. При нагріванні кристала відбувається перерозподіл електронів по енергіях. Наслідком неоднорідності такого перерозподілу кристалі є перенос кінетичної енергії, що приводить до теплопровідності. По своїй природі електронна теплопровідність
115
аналогічна теплопровідності звичайного газу, тому можна скористатися формулою теплопровідності для газу

де u - середня теплова швидкість електронів; / - середня довжина
їхнього вільного пробігу; Cv - питома теплоємність при постоян-
ном обсязі.

де п-концентрация електронів; k - постійна Больцмана. Тоді коефіцієнт електронної теплопровідності

Електронна теплопровідність пропорційна концентрації носіїв заряду, їхньої швидкості і довжині вільного пробігу. Аналогічна залежність спостерігається для електропровідності напівпровідників

Знайдемо відношення теплопровідності до електропровідності



де Коефіцієнт-а-коефіцієнт, що залежить від ступеня виродження элект-ройного газу і механізму розсіювання носіїв заряду. Для реше-ток з ковалентними зв'язками Л=2.
Отримане вираження зветься закону Видемана -Франца. У примесных напівпровідниках теплопровідність підкори ется цьому закону. В області високих значень температур, де в напівпровідників спостерігається власна електропровідність, закон Видемана- Франца не дотримується. Це порозумівається сле образом, що дує.
В області температур, що відповідають власної электро-проводности, на гарячому кінці напівпровідника крім збільшення
116
кінетичної енергії збільшується концентрація носіїв заря-да за рахунок генерації электронно-дырочных пара. Тому начина-этся дифузія носіїв з області з більшою концентрацією в область з меншої. Па холодному кінці электронно-дырочные пари будуть рекомбинировать з виділенням енергії, приблизно рівній Ірині забороненої зони. Отже, у напівпровіднику із соб-ственной електропровідністю виникає додатковий потік тепла і додаткова теплопровідність. При цьому зазначений потік перевершує по величині потік тепла, обумовлений раз-личием кінетичної енергії електронів. Решеточная теплопровідність уперше була пояснена П. Деба-Він висунув ідею взаємодії пружних хвиль у твердому результатом якого є решеточная теплопровідність.
Якщо в кристалі мається градієнт температури, то распространение фононів не буде рівноважним. Зіткнення між фононамі будуть упорядковувати їхній рух, створюючи умови для періходу рівноважному стану. Швидкість процесу відновленнярівноважного стану фононів визначає величину теплопровід-
ности. Дебай вивів формулу теплопровідності волі ґрати, используя вираження для коефіцієнта теплопровідності, відоме кінетичної теорії газів:

одержуємоОскількиЦе відношення є величина постійна, залежна тільки від температури.З урахуванням розподілу електронів по енергіях вираження приймає видде З - питома теплоємність; v - швидкість поширення уп-ругих хвиль, т. е: швидкість звуку в кристалі; / - середня довжина вільного пробігу хвиль штахетів-фононів.
Процес теплопереноса, обумовлений тепловими коливаннями ґрат, можна представити як рух і розсіювання фононів. На розсіювання фононів і величину довжини вільного пробігу в реальних кристалах сильний вплив робить ряд факторів: температура, домішки і дефекти ґрат і т.д. Температурний хід теплопровідності обумовлений в основному температурної зависи-мостю довжини вільного пробігу фононів. При низьких температурах у кристалі маються лише довгохвильові коливання, що розсіюються тільки на дефектах чи ґрат на зовнішніх шах кристала. Тому в області низьких температур решеточная теплопровідність зростає зі збільшенням температури.
В міру росту температури кількість фононів у кристалі росте. Це збільшує теплопровідність. Подальший ріст кількості фононів приводить до виникнення фононної взаємодії, у результаті чого теплопровідність, досягши максимуму, починає спадати.
Довжина вільного пробігу фононів знаходиться в сильної зависимогти від температури Дебая. Чим вище температура Дебая, тим при даній температурі кристала менше число фононів, менше зіткнень між ними і більше довжина їхнього вільного пробігу.
117
Контрольні питання і задачі
1. Обчислити довжину вільного пробігу, що пройде електрон у силь
ном електричному полі, якщо критична напруженість полючи дорівнює 2>
Х10 В/див? Температура кімнатна.
2. У яких напівпровідниках (власних чи примесных) при низьких
температурах критична напруженість більше?
3. Який параметр ( чи п) сильніше залежить від напруженості полючи п
сильних електричних полях і чому?
4. Яка область в. а. х. (мал. 5.5) відповідає процесу утворення
електричного домена?
5. Чому в кристалі може існувати одночасно тільки один
електричний домен?
6. Виникали б у напівпровіднику високочастотні коливання, якби
долини, розділені потенційним бар'єром, знаходилися не в зоні проводь
мости, а у валентній зоні?
7. Обчислити частоту високочастотних коливань, що виникають у зразку
напівпровідника довжиною І мкм, якщо Епор=6 кв/див, а рухливість електронів
у верхній долині =30Про див2/(З).
8. Від чого залежать час життя т і дифузійна довжина L нерівновагих
носіїв заряду?
9. Яким образом у напівпровіднику можна створювати нерівновагі носи
тели заряду?
10При яких умовах спостерігається дифузія нерівновагих носіїв
заряду в напівпровідниках?
11. Обчислити коефіцієнти дифузії електронів і дірок у германії при Т=27°С, якщо -3800 див2/(З), -1900 див2/(З).
12. У деякій крапці однорідного електронного напівпровідника світловим
зондом генеруються пари носіїв. Визначити дифузійну довжину дірок.
якщо концентрація нерівновагих дірок на відстані х, = 2 мм від зонда дорівнює
р, = 1014 див-3, а на відстані .х2=4,3 мм, р2=1013 див-3.
13. Електроди, на яких вимірюють э.д. с. Холу, повинні розташовуватися
строго друг проти друга, тобто на эквипотенциальных поверхнях. З ньому це
зв'язано?
14. Напівпровідникова пластина квадратного перетину зі стороною 1 мм
поміщена в магнітне поле з індукцією В. Тік, що проходить через пластину,
дорівнює 50 ма. Величина різниці потенціалів, що утворилася, Холу складає
Uх = 10 мв. Визначити індукцію В, якщо концентрація носіїв заряду
дорівнює 1016 див-3.
15. В скількох разів повинні відрізнятися швидкості електронів у металі і
напівпровіднику, якщо величина э.д. с. Холу, що утворилася в них, однакова
й однакові всі інші умови?
16. Обчислити, при якім співвідношенні концентрацій електронів і дірок
у примесном германії э.д. с. Холу стає рівної кулю, якщо рухливості
електронів і дірок рівні відповідно n=3900 див2/(Вс) і Р =
= 1900 див2/(З).
17.Визначити температуру Дебая в для матеріалу, у якому максималь
ная частота коливань складає 1013 1/с.
18. Чим обмежується довжина пружної хвилі у твердому тілі при низьких
і високих температурах?
19. Чому в реальних кристалах теплопровідність має кінцеве зна
ченне?
20. Що є причиною розсіювання пружних хвиль у твердому тілі?
