Рецензенти: доц. Московського станкоинструментального інституту, канд техн наук Г. И. Гранітів; викладач Московського технікуму електронних приладів А. В. Закревская Гаркуша Ж. М
| Вид материала | Документы |
СодержаниеЗаряду за допомогою мдп-структур 9.7. Канали провідності |
- Україна харківська міська рада харківської області виконавчий комітет управління освіти, 181.85kb.
- Гост 17623-87, 138.94kb.
- М. А. Ляшко доц., канд физ мат наук; Т. Н. Смотрова доц., канд, 2299.13kb.
- Надійності та безпеки в будівництві, 692.13kb.
- Гост 5382-91, 1729.88kb.
- Д. М. Лаковский (руководитель темы); И. В. Колечицкая; С. А. Резник, канд техн наук;, 203.82kb.
- Гост 14637-89: Прокат толстолистовой из углеродистой стали обыкновенного качества Технические, 310.23kb.
- Государственный стандарт союза сср здания и сооружения Методы измерения яркости, 278.78kb.
- Гост 26824-86, 248.28kb.
- Строительные нормы и правила отопление, вентиляция и кондиционирование, 2477.63kb.
У випадку утворення збагачених і інверсійних шарів концентрація носіїв заряду на поверхні виявляється більшої, ніж в обсязі кристала. Надлишкові носії заряду при додатку електричного полючи до кристала рухаються по поверхні кристала направленно, здійснюючи тим самим поверхневу електропровідність. Наявність поверхневої електропровідності веде до зміни електропровідності кристала в цілому. Особливо істотно ця зміна при малих розмірах зразка.
Поверхневу електропровідність визначають як різниця значень електропровідності кристала при даному поверхневому потенціалі і при нульовому потенціалі.
Розглянемо характер зміни поверхневої електропровідності для напівпровідника n-типу при зміні поверхневого потенціалу від деякого максимального позитивного значення до максимального негативних. Зміна поверхневого потенціалу можна здійснювати шляхом адсорбції різних часток на поверхні. При максимальному позитивному потенціалі зони напівпровідника загинаються вниз. На поверхні утвориться збагачений шар (мал. 9.9,а), тому поверхнева електропровідність максимальна і здійснюється основними носіями заряду. При зменшенні поверхневого потенціалу загин зон зменшується, концентрація електронів у збагаченому шарі знижується, поверхнева електропровідність падає. При кульовому поверхневому потенціалі поверхнева електропровідність дорівнює нулю, зони напівпровідника розташовані горизонтально. При невеликому
196
негативному потенціалі енергетичні зони загинаються нагору, на поверхні напівпровідника утвориться збіднений шар, електропровідність на поверхні стає менше, ніж об'ємна, і змінює знак (мал. 9.9,6). Зменшення електропровідності про- виходить доти , поки на поверхні не виникне инверсион ный

шар. З утворенням інверсійного шару поверхнева електропровідність почне зростати. Коли електропровідність зразка стане рівної об'ємний, поверхнева електропровідність звернеться в нуль (мал. 9.9, в). Подальше збільшення негативного потенціалу приведе до зростання концентрації дірок в інверсійному шарі, поверхнева електропровідність буде рости і здійснюватися за допомогою неосновних носіїв заряду - дірок (мал. 9.9, г). Графік зміни поверхневої електропровідності для електронного напівпровідника представлений на мал. 9.10. Тут же для порівняння представлені графіки
зміни поверхневої електропровідності для власного і дырочного напівпровідником. В останньому мінімум електропровідності зміщений убік позитивних значень поверхневого потенціалу; у власному напівпровіднику - убік негативних значень. Мінімум у власному напівпровіднику при невеликому негативному потенціалі порозумівається тим, що подвиж-
197
н
 ость електронів більше рухливості дірок. Порівняємо зміну поверхневої електропровідності для декількох напівпровідників n-типу з різним питомим опором. Неважко: помітити, що чим більше питомий опір напівпровідника, тим легше на його поверхні утвориться інверсійний шар (мал. 9.11). А це значить, що для одержання однакової по величині поверхневої електропровідності, здійснюваної неосновними носіями заряду - дірками, потрібно створити на поверхні напівпровідника з меншим питомим опором більший негативний по-
ость електронів більше рухливості дірок. Порівняємо зміну поверхневої електропровідності для декількох напівпровідників n-типу з різним питомим опором. Неважко: помітити, що чим більше питомий опір напівпровідника, тим легше на його поверхні утвориться інверсійний шар (мал. 9.11). А це значить, що для одержання однакової по величині поверхневої електропровідності, здійснюваної неосновними носіями заряду - дірками, потрібно створити на поверхні напівпровідника з меншим питомим опором більший негативний по-верхностный заряд, чим на напівпровідниках з великим питомим опором.
Графіки залежності поверхневої електропровідності для напівпровідників n-типу з різним ступенем легування приведені на мал. 9.12.
Поверхнева електропровідність залежить від температури. При підвищенні температури збільшується концентрація носіїв заряду, рівень Ферми у випадку іонізації донорів підвищуються і криві зміщаються убік з великими значеннями негативного поверхневого потенціалу (мал. 9.13).
Експериментальні дослідження поверхневої електропровідності, проведені Л. В. Ржановым, дали цікаві результати. Досвіди проводилися з напівпровідниками р- і n-типів, що мають різний питомий опір, обробленими в киплячій концентрованому перекисі водню з добавкою лугу і травителе з фтористоводородной і азотної кислот типу СР.
Зміна поверхневої електропровідності здійснювалося в ході газового циклу Браттейна - Бардіна. Результати экспери-
198
мента показали, що характер зміни поверхневої електропровідності для зразків з питомим опором вище 6- 7 Ом-см Визначається видом хімічної обробки і не залежить від типу електропровідності напівпровідника, а характер зміни електропровідності низкоомных зразків визначається тільки типом електропровідності. За допомогою цих експериментів було підтверджено, що травленню, у перекисі водню супроводжує об-разование позитивного поверхневого заряду, а в травителе СР - негативного заряду.
На величину поверхневої електропровідності впливає зміна рухливості електронів і дірок в області просторового заряду. При зіткненні з поверхнею носії заряду випробують розсіювання, ступінь якого залежить від величини элек-троетатического потенціалу на поверхні і виражається в зміні швидкості руху носіїв заряду. Зміна дрейфової швидкості носіїв веде до зміни їхньої рухливості. Величина рухливості в області просторового заряду залежить від механізму розсіювання носіїв заряду поверхнею - дзеркального чи дифузійного. При слабкій взаємодії спостерігається дзеркальне розсіювання: після відображення носія від поверхні величина його швидкості не міняється, але напрямок вектора швидкості змінюється па протилежне. При чисто дзеркальному відображенні рухливість носіїв заряду в поверхні така ж, як у глубене зразка.
При дифузійному розсіюванні міняється величина швидкості, а вектор швидкості може прийняти будь-як напрямок. Рухливість носіїв заряду зменшується тим сильніше, чим більше величина поверхневого заряду.
§ 9.5. ЕФЕКТ ПОЛЯ ;
Величину поверхневого потенціалу можна змінювати за допомогою зовнішньої напруги, прикладеного до структури метал - діелектрик - напівпровідник (мал. 9.14). Таку структуру називають Мдп-структурой чи Моп-структурой, якщо як діелектрик використовується оксидна плівка. Представимо цю структуру відповідно до схеми, показаної на мал. 9.15: електронний напівпровідник - у виді зонної діаграми, метал - у виді пластинки, а шар діелектрика - у виді зазору між ними. Нехай у пеход-ном стані поверхневий заряд напівпровідника отсутствует, і границі зон розташовані горизонтально. Ця структура аналгична будівлі плоского конденсатора, однією обкладкою якого служить метал, іншої - напівпровідник. Якщо до металевої обкладки прикласти позитивний полюс джерела, то заряд цієї обкладки повинний бути скомпенсований негативним зарядом, наведеним па противолежащей обкладці - поверхні напівпровідникового матеріалу. Для напівпровідника n-типу негативний заряд створюють електрони, що, скапливаясь у поверхні,
199
утворять збагачений шар. Це веде до скривлення енергетичних зон напівпровідника вниз.
Змінюючи величину прикладеної напруги, змінюють концентрацію носіїв заряду в збагаченому шарі і тим! самим - величину поверхневої електропровідності.

При зміні полярності прикладеної напруги і невеликих його значень компенсація негативного заряду металевої обкладки здійснюється позитивними зарядами донорів,
у результаті чого в поверхні напівпровідника утвориться збіднений шар. Енергетичні зони напівпровідника викривляються нагору. При збільшенні напруги в компенсації негативного заряду беруть участь не тільки іонізовані донори, але і дірки інверсійного шару, що скапливаются в поверхні. Утворення інверсійного

шару приводить до появи поверхневої електропровідності,здійснюваної неосновними носіями заряду. Величина електропровідності також міняється при зміні прикладеної напруги. Ефект зміни поверхневої електропровідності кристала під дією електричного полючи, прикладеного до його поверхні, називають ефектом полючи.
Говорячи про поверхневу електропровідність, ми не враховували поверхневі стани, що завжди маються в напівпровіднику і положення яких фіксоване щодо енергетичних зон. При зміні загину зон зміщаються поверхневі рівні і міняється їхнє положення щодо рівня Ферми, що визначає ступінь заповнення цих рівнів носіями заряду (мал. 9.15).
Утворення різних шарів на поверхні змінює характер і ступінь заповнення поверхневих рівнів. Не всі носії заряду збагаченого й інверсійного шарів беруть участь
200
у поверхневій електропровідності, оскільки частина буде знаходитися в зв'язаному стані на поверхневих рівнях. Чим більше концентрація поверхневих рівнів, тим більше носіїв захоплюються ними і тем менше величина поверхневої електропровідності.


Таким чином, заряд металевої обкладки конденсатора компенсується не тільки зарядом у приповерхньому шарі, але і зарядом поверхневих станів:
Величину повного заряду конденсатора для кожного відомого значення прикладеної напруги V легко розрахувати, вимірюючи ємність З конденсатора:

Якщо побудувати експериментальний графік залежності поверхневої електропровідності від величини повного заряду Q і па ротом же графіці нанести теоретичну залежність поверхневої електропровідності від заряду в приповерхньому шарі, сполучивши мінімуми кривих (мал. 9.16), то для того самого зна-чения поверхневої електропровідності на обох кривих але різниці значень Q і QUнов можна визначити заряд поверхневих рівнів.
Г Побудуємо графік залежності поверхневої електропровідності від прикладеного до структури напруги і тут же-графік теоретичної залежності поверхневої електропровідності від потенціалу загину зон (мал. 9.17). Сполучаючи мінімуми кривих, можна для кожного значення поверхневої' електропровідності визначити залежність ступеня загину енергетичних зон від величини прикладеної напруги (мал. 9.18).
201
Величина вигину зон при напрузі, рівній нулю, визначає
початковий вигин зон.
За допомогою ефекту полючи досліджують процеси обміну носіями заряду між поверхневими рівнями й обсягом напівпровідника. Для цього визначають зміна поверхневої електропровідності в часі від моменту додатка електричного полючи (мал. 9.19). Як видно з приведеного графіка, з моменту включення полючи протягом часу 10~8 з поверхнева електропровідність сильно змінюється. Потім спад сповільнюється і при t>10-5 із установлюється деякий рівноважний стан. Нарешті, від моменту часу t>10-3 з до одиниць секунд, а в деяких
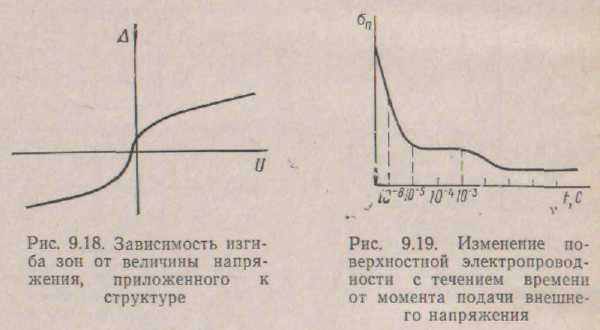
випадках до декількох годин, установлюється стаціонарна поверхнева електропровідність.
Зменшення поверхневої електропровідності порозумівається захопленням носіїв заряду поверхневими рівнями. Дві різних по швидкості зміни поверхневої електропровідності стадії вказують на те, що на поверхні маються дві різні системи поверхневих станів. Одна система рівнів характеризується часом захоплення носіїв порядку 10-8 з, ці рівні називають швидкими поверхневими станами. Інша cucтема рівнів має час захоплення носіїв заряду більш 10-3 з, ці рівні називають повільними поверхневими станами. Велике розходження в часах захоплення носіїв обумовлено розходженням у місці розташування швидких і повільних станів. Розглядаючи будівлю реальної поверхні напівпровідників, ми відзначали, що поверхневі рівні маються па поверхні напівпровідників і оксидів.
Рівні, розташовані на поверхні напівпровідника, знаходяться в гарному електричному контакті з ним, тому вони є швидкими. Обмін носіями заряду з рівнями, розташованими на поверхні й усередині оксиду, утрудненийі, тому ці рівні відносять до повільного. Концентрація повільних станів
202
досить велика. Згодом усі носії, індуковані електричним полем, захоплюються повільними станами і поверхневою електропровідністю звертається в нуль.
Важливою властивістю Мдп-структуры є залежність її ємності від величини прикладеної напруги. Це зв'язано з тим, що при зміні прикладеної напруги змінюється товщина шаруючи приповерхнього заряду.
У випадку утворення приповерхнього збагаченого шару його товщина дуже мала - носії скапливаются в поверхні і ємність Мдп-структуры змінюється незначно. Коли на поверхні утвориться збіднений шар, його товщина досить велика і ємність Мдп-структуры зменшується. При утворенні збідненого шару ємність структури можна представити у виді двох конденсаторів, з'єднаних послідовно. Одним являстя конденсатор, обумовлений діелектричним шаром, його ємність постійна і дорівнює

де ед - діелектрична проникність діелектрика; dд - товщина діелектрика.
І Інший конденсатор утворений збідненим шаром напівпровідника, його ємність залежить від прикладеної напруги:

де еи - діелектрична проникність напівпровідника, 1про-
товщина збідненого шару.
Повна ємність Мдп-структуры

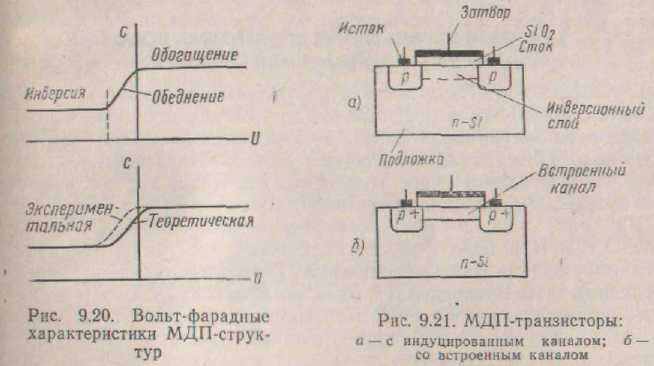
203
Зміна ємності Мдп-конденсатора буде відбуватися до того моменту, поки в напівпровіднику не почне створюватися інверсійний шар (мал. 9.20). Приведену на малюнку криву називають вольт-фарадной чи C-V-характеристикою.
Розглянута зміна ємності Мдп-структури не враховує наявності поверхневих станів, що роблять вплив на розподіл зарядів між поверхнею і поверхневими рівнями. З урахуванням зарядів поверхневих рівнів C-V-характеристика зрушується по осі напруг у залежності від знака поверхневого заряду в ту чи іншу сторону.
На підставі величини цього зрушення визначають величину заряду поверхневих станів і щільність поверхневих рівнів.
За допомогою ефекту полючи можна вивчати поверхневі властивості напівпровідників: поверхневу електропровідність, поперх-ностный потенціал і параметри поверхневих станів. Існує багато експериментальних методів дослідження ефекту полючи як у стаціонарному, так і в динамічному режимах. Виміру можна виконувати на постійній і перемінній напругах, в імпульсному режимі, па низкою і високою частотами.
На основі Мдп-структуры створені польові транзистори з ізольованим затвором, з індукованими й убудованими каналами (мал. 9.21). У транзисторів з індукованим каналом при подачі напруги між стоком і джерелом і відсутності напруги на металевому електроді - затворі - струм проходити не буде, тому що один з переходів (стік - чи підкладка джерело - підкладка) включений у зворотному напрямку.
При подачі на затвор напруги такої полярності і величини, щоб у підкладці під шаром оксиду утворився інверсійний слон, стік і джерело з'єднаються між собою каналом - інверсійним шаром, по якому йде струм. Змінюючи величину напруги на затворі, можна змінювати електропровідність інверсійного шару і тим самим величину струму, що проходить між стоком і джерелом.
§ 9.6. ФІЗИЧНІ ЯВИЩА ПРИ ПЕРЕНОСІ НОСІЇВ
ЗАРЯДУ ЗА ДОПОМОГОЮ МДП-СТРУКТУР
За допомогою Мдп-структур здійснюють збереження заряду неосновних носіїв у потенційних ямах, що виникають поблизу поверхні напівпровідника під впливом зовнішнього електричного полючи. Потенційні ями можуть переміщатися уздовж поверхні, здійснюючи перенос неосновних носіїв заряду. Розглянемо процес утворення потенційних ям.
На підкладці n-типу одержують кілька Мдп-структур (мал. 9.22). При подачі на металеві електроди негативної напруги під електродами в напівпровіднику одержують збіднені чи інверсійні шари, що називають потенційними чи ямами кишенями. У потенційних ямах накопичуються неосновні носії заряду-дірки. Ці дірки утворяться в кристалі за рахунок теплової генерації, а тому що швидкість генера-
204
ции по всьому кристалі однакова, то заповнення кишень буде рівномірним. Процес нагромадження дірок у кишенях таким шляхом йде порівняно повільно. Якщо усередині якої-небудь кишені потрібно створити підвищену концентрацію дірок, то це здійснюють за допомогою інжекції электронно-дырочным переходом, розташованим поблизу кишені, чи ннжекцией світловим зондом.
Оптичний метод у порівнянні з інжекцією р-n-переходом має ряд переваг: заряд можна внести в будь-яку кишеню в будь-якій послідовності; час генерації фотоносіїв складає 10-12 с.
При розташуванні електродів на невеликій відстані друг від друга (менш трьох мікрометрів) їх полючи перекриються. Якщо заряд в одній кишені більше, ніж в іншому, почнеться перетекание дірок у кишеню з меншою концентрацією. Воно буде продовжуватися до тих піп, поки заряди в кишенях не зрівняються.
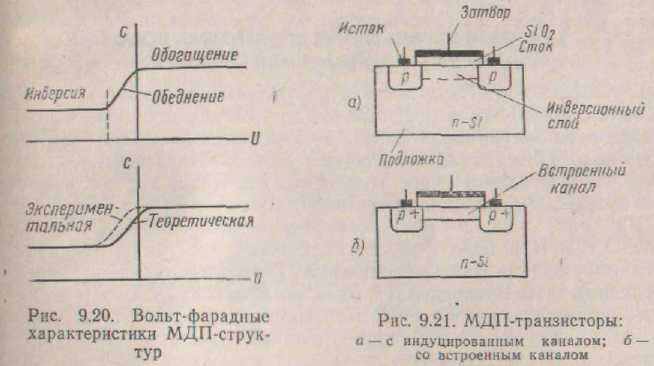
При подачі на електроди напрузі різної величини глибина кишень буде різної і під впливом полючи, що діє між кишенями, дірки будуть перетікати в більш "глибокий" кишеню. Для запобігання зворотного перетекания електроди поєднують у групи по трьох і приєднують до шин харчування (мал. 9.23). Якщо заряд накопичений, наприклад, під другим електродом і потрібно передати його в наступний, третю кишеню, то на третій електрод подають напруга більше, ніж на другому; дірки перейдуть у третю кишеню. Потім більша напруга подається на четвертий електрод і дірки переміщаються в четверту кишеню. Одночасно з подачею напруги на четвертий електрод таку ж напругу подають і на перший, але перетекания дірок у першу кишеню не буде, тому що між першою і третьою кишенями розташований другий.
Таким чином, якщо в першу кишеню ланцюжка ввести заряд, то при відповідному зміні напруги на шинах харчування можна здійснити передачу заряду з однієї кишені в іншій по всьому ланцюжку. Якщо на виході ланцюжка мається включений у зворотному напрямку діод, то поява заряду викликає зростання зворотного струму діода.
205
Перетекание носіїв з кишені в кишеню відбувається двома шляхами: дрейфом і дифузією. Швидкість дрейфу приблизно на два порядки перевищує швидкість дифузії, тому під дією полючи переноситься близько 98% носіїв. Однак у міру перетекания носіїв заряду напруженість полючи спадає і швидкість дрейфу знижується. Носії, що залишилися в кишені, продовжують дифундувати, але через низьку швидкість дифузії знижується швидкодія всього ланцюжка. При переключенні напруги раніш моменту перетекания всіх носіїв носії, що залишилися в кишенях, являють собою втрати в ефективності їхньої передачі. Хоча для окремої кишені ці потерн складають лише одиниці відсотка, загальний коефіцієнт передачі буде дорівнює добутку коэф-

фициентов передачі всіх кишень.
Число елементів у ланцюжку може складати кілька сотень, а це значить, що втрати складуть десятки відсотків. Крім того, частина носіїв заряду захоплюється поверхневими пастками. На пастках носії можуть утримуватися протягом часу, що
перевищує час переключення, тому вони не будуть устигати переходити з однієї кишені в іншій.
Для заповнення дірок, що залишаються в кишенях, між структурами поміщають спеціальні схеми відновлення (регенерації) зарядів. Для зменшення втрат дірок нагромадження і перенос їх можна здійснювати не на поверхні напівпровідника, а в його обсязі, де концентрація ловвушек і інших дефектів на два порядки нижче. З цією метою під поверхнею напівпровідника створюють перехід (мал. 9.24). Такі структури називають структурами з об'ємним чи схованим каналом. При подачі па р-n-переход па-пряжения в зворотному напрямку утвориться потенційна яма, глибина якого збільшується при подачі напруги на затвор. Введені в потенційну яму носії заряду переміщаються з однієї ями в іншу по каналі, не виходячи до поверхні. Утрати носіїв при цьому різко упадуть і складуть приблизно 10-5.
Прилади, що працюють на розглянутому принципі, називають приладами з зарядовим зв'язком - ПЗС. Основними напрямками використання ПЗС є створення швидкодіючих запам'ятовуючих пристроїв, побудова формирователей відеосигналу, створення пристроїв аналогової обробки інформації.
Бурхливий розвиток виробництва ПЗС порозумівається їх високими техніко-економічними показниками, широкими можливостями використання в оптоелектроніці, радіолокації, обчислювальній техніці, кольоровому телебаченні і телефонії.
Прилади з зарядовим зв'язком характеризуються високою щільністю упакування - до 5-105 см~3, малою споживаною потужністю, простотою технології виготовлення, високою швидкодією.
206
§ 9.7. КАНАЛИ ПРОВІДНОСТІ
При утворенні позитивного заряду на поверхні напівпровідника р-типа і негативного на поверхні напівпровідника n-типу можливе виникнення інверсійних шарів (мал. 9.25). Ці шари створюють р-n-переход у приповерхній області полупро-нодника. Якщо інверсійний шар виникає на структурі з р-n-пі-

реходом, те область переходу витягається уздовж поверхні кристала (мал. 9.26). Частина інверсійного шару, укладеного між поверхнею напівпровідника й областю об'ємного заряду, називають каналом.

Наявність каналів збільшує ефективну площу р-n-пере-хода, що при зворотному напрямку р-n-перехода приводить до росту зворотного струму. Величина надлишкового зворотного струму, обумовленого каналом. залежить від довжини капала:

де lк - надлишковий струм на единицу довжини капала; І - довжина капала.
На відстані х від початку каналу величина струму визначається вираженням

Зворотна напруга розширює р-n-переход в області каналу майже паралельно поверхні. Опір каналу через малу площу його перетину буде відносно високим.
Канальний струм обумовлює спадання напруги уздовж капала, тому різниця потенціалів між інверсійним шаром і обсягом напівпровідника зменшується в міру видалення від основного р-n-перехода. Тому що ширина р-n-перехода залежить від прикладеної напруги, то в міру видалення від основного перехо-
207
так ширина переходу в каналі буде зменшуватися і на деякій визначеній відстані х, що залежить від багатьох факторів, канал зникне. Цю відстань називають довжиною каналу.
Оскільки зворотний струм досягає насичення при напрузі, приблизно рівному k/e, те за довжину каналу прийняте відстань, на якому

З цього можна зробити висновок, що опір каналу пропорційно напрузі:

де U(x) -спадання напруги уздовж каналу; А - коефіцієнт пропорційності, що залежить від навколишнього середовища. Тоді для перетину х можна записати
Інтегруючи це вираження при початкових умовах: на початку каналу при х=0 U = U0, де U0, -прикладене до переходу напруга, наприкінці каналу при x=l U=Uк ,UK - напруга наприкінці каналу, одержимо

Звідси довжина каналу

ок каналу

Можливі випадки розігріву каналу минаючим струмом, що може привести до локалізованого пробою, а отже, і до збільшення струму каналу.
Утворення каналів можливо після травлення зразків у розчинах суміші фтористоводородной і азотної кислот, промивання і сушіння.
Довжина каналу залежить від навколишньої газового середовища і часу витримки в пий.
Канали легше утворяться на слаболегированных напівпровідниках, чим на силынолегированных, тому що чим слабкіше легований напівпровідник, тим при меншому заряді утвориться на ньому инвер-
208
сиойный шар. На напівпровідниках n-типу канали утворяться в атмосфері озонованого кисню, на напівпровідниках р-типа - у вологій атмосфері. Практично канали починають створюватися при вологості порядку 30%, однак довжина їх невелика. Максимальна довжина каналу, досягнута на зразках германія при вологості 92%. складала 1,15 мм.
Канал можна переміщати з однієї області напівпровідника в іншу, змінюючи середовище, у якій знаходиться зразок з р-n-переходом.
Канал, що утворився в р-области напівпровідника з р-n-переходом у вологому середовищі, можна видалити шляхом короткочасної видержки зразка в атмосфері озонованого кисню, але при Ном виникає капав у n-області напівпровідника. У На кремнієвих переходах досягнута довжина каналу близько 4 мм. У планарных транзисторів заряд на границі роздягнула Sі-Sі2 позитивний, тому канал може виникнути в р-области. Для транзисторів п-р-п - це область бази. Ступінь її легування до-статочно висока (Na=1018 див-3), тому для виникнення ін-версії поверхневий заряд повинний бути досить великим, по-рядка 2-1012 див-2. При виготовленні транзисторів цей заряд обыч-но не перевищує (5-3-8) o 1011 см~2. При підвищенні температури можлива генерація додаткового заряду, що приводить до воз-никновенно каналу
