Метрологическое обеспечение, стандартизация и оценка соответствия нанотехнологий и нанопродукции (Аналитический обзор) Ростехрегулирование ноябрь – 2007 г. Содержание
| Вид материала | Реферат |
- Аннотация рабочей программы учебной дисциплины «опд. Р02 метрологическое обеспечение, 148.39kb.
- Р абочий материал конференции «Актуальные вопросы и метрологическое обеспечение в сфере, 369.53kb.
- Русский обозреватель” информационно исследовательский центр информационно-аналитический, 4335.53kb.
- Методическое и метрологическое обеспечение усилителей мощности в диапазоне частот 0,05-2, 12.44kb.
- Электронный образовательный ресурс «Геометрические построения» является обучающим комплексом,, 34.88kb.
- Седьмая Всероссийская научно-техническая конференция «Метрологическое обеспечение обороны, 106.03kb.
- V-я всероссийская научно-практическая конференция «метрологическое обеспечение весоизмерительной, 51.17kb.
- Метрологическое обеспечение производства в свете новой редакции закона «Об обеспечении, 41.44kb.
- «Обзор инновационных, экологически безопасных строительных и отделочных материалов,, 16.32kb.
- Аналитический обзор нормативных правовых актов, регламент, 713.14kb.
3. МЕТРОЛОГИЧЕСКОЕ ОБЕСПЕЧЕНИЕ
Для успешного развития нанотехнологий, наноиндустрии и нанорынка одним из важнейших обеспечивающих направлений является метрологическое обеспечение.
История развития науки и техники неразрывно связана с развитием системы методов и средств измерений. Переход к нанотехнологиям ставит перед наукой и техникой ряд новых специфических задач , обусловленных малыми размерами элементов и структур, с которыми имеет дело нанотехнологии.
При этом, как никогда, актуален тезис: «если нельзя измерить, то невозможно создать».
Специфика нанотехнологий привела к созданию и развитию нового направления в метрологии, с которым связаны все теоретические и практические аспекты обеспечения требуемой точности и единства измерений в нанотехнологиях.
В метрологическом обеспечении нуждаются как сам технологический процесс создания новых наноструктур, основанный на управлении перемещениями атомов, молекул или молекулярных систем в пространственных областях длин нанометрового диапазона, так и измерения параметров создаваемых наноустройств, а также характеристик материалов со специальными физическими, химическими и биологическими свойствами. Особую задачу представляют съем и обработка измерительной информации с устройств столь малых размеров, обеспечение достоверности и метрологической надежности измерений, выполняемых при этом.
Следует отметить, что измерения и контроль некоторых параметров технологических процессов в области нанотехнологий и применения наноустройств, а также характеристик материалов со специальными физическими, химическими и биологическими свойствами, создаваемых в результате промышленного применения нанотехнологий, во многих случаях осуществляется в рамках обычной метрологии. Однако новые характеристики и возможности изделий наноиндустрии и свойства материалов, создаваемых в результате применения нанотехнологий, предъявляют особые требования к применяемым средствам измерений и их метрологическому обеспечению. Эти средства измерений должны обладать новыми функциональными возможностями, расширенными диапазонами измерений и повышенной точностью, что ужесточает требования к уровню обеспечения единства измерений в стране. В первую очередь это относится к точности, диапазонам измерений и функциональным возможностям первичных эталонов и обусловливает необходимость их направленного совершенствования, а также, возможно, и создания для России новых, исходных эталонов. Понятно, что решение проблем метрологического обеспечения нанотехнологий не ограничивается совершенствованием эталонов, требуется модернизация существующего и создание более современного, отвечающего новым задачам поверочного оборудования, а также разработка нормативных документов на методы и средства поверки средств измерений, применяемых в наноиндустрии и других областях использования нанотехнологий, на методики выполнения измерений в связи с развитием нанотехнологий.
Насколько существенно повышение метрологических требований при переходе к наноразмерам можно проиллюстрировать на примере полупроводниковой микроэлектроники при ее развитии «сверху – вниз» в направлении наноэлектроники.
Метрология – ключевое звено для полупроводниковой промышлен-ности и будет оставаться таковым для будущих поколений полупроводниковых приборов до тех пор, пока размеры элементов полупроводниковых структур будут уменьшаться.
В логических схемах и микропроцессорах уже приближаются к созданию структур атомарных размеров. В ближайшем будущем длина затвора транзисторов будет приближаться к 25 нм или даже меньше. Такой затвор меньше ширины 5 элементарных ячеек. Это и является нанотехнологией, требующей точной нанометрологии. Для многих компаний уже становится абсолютно очевидными проблемы связанные с уровнем точности, требуемой для нанометрологии.
Международная организация International SEMATECH, спонсорами которой являются:
Ассоциация полупроводниковой промышленности США (Semiconductor Industry Association), Европейская ассоциация электронных компонент (European Electronic Component Association), Accoциация электронной промышленности Японии (Electronic Industries Association of Japan), Ассоциация электронной промышленности Кореи (Korea Electronic Industries Association) и Ассоциация электронной промышленности Тайваня (Taiwan Electronic Industries Association), разработала маршрутную карту ITRS изменения метрологических требований по мере уменьшения критических размеров полупроводниковых элементов. Данная маршрутная карта приведена на рисунке 3.

Рисунок 3 Маршрутная карта ITRS.
Некоторые из технологических узловых пунктов, находящихся при 100 нм или ниже 100 нм2, не имеют пока очевидных решений, и в настоящее время выполняется работа в области нанометрологии для того, чтобы найти эти решения.
Метрологическая программа нано-метрового диапазона Национального института стандартов и технологий CIF (NIST) нацелена на решение некоторых из указанных задач, которые находятся в рамках компетенции NIST.
Влияние и результаты использования точных эталонов на полупроводниковую индустрию были проанализированы, когда мировая продажа фотошаблонов составила около 375 млн долл. в год. Использование точного эталона NIST для ширины линии позволило промышленности сэкономить в год до 30 млн долл. С тех пор как было выполнено указанное первоначальное исследование, в 2001 г. рынок фотошаблонов возросло до величины, которая оценивается в 2 млрд долл. В течение ряда лет NIST ввел серию более точных эталонов ширины линии, и в настоящее время готовится к выпуску новый эталон.
Экспертные оценки показывают, что на метрологическое обеспечение развития микроэлектроники в направлении наноэлектроники в США ежегодно тратиться более 4.0 млрд. долларов.
Фирмой Energetics, Inc по заказу NIST был подготовлен следующий перечень основных «метрологических барьеров» на пути нанотехнологических инноваций:
• Отсутствие достаточного количества измерительных преобразова-телей и устройств, предназначенных для:
- обнаружения и последующего лечения заболеваний, вызванных
инфекциями и нарушениями питания, включая авитаминоз;
- решения задач в области здравоохранения;
- выявления и прослеживания развития патогенных микроорганизмов в пищевых и сельскохозяйственных продуктах и культурах;
- использования в наносепараторах и нанобиореакторах;
- обеспечения безопасности для здоровья человека пищевых
продуктов;
- количественного описания влияния окружающей среды и деградации
почв;
- создания предохраняющих от загрязнений наноповерхностей
(например, при упаковке продуктов).
• Необходимость обеспечения широкого диапазона измерений,
связанных с исследованиями, описаниями свойств, синтезом новых
наноматериалов, а именно, с:
- описанием и разработкой путей, методик и средств измерений свойств наноматериалов;
- разработкой путей развития инфраструктуры;
- разработкой национальных стандартов и международных соглашений, касающихся синтеза и анализа наноматериалов;
- созданием строгой и четкой системой практической метрологии в
промышленности;
-разработкой зондов и измерительных головок для выполнения измерений и моделирования в процессе синтеза наноматериалов;
- измерениями воздействий наноматериалов на окружающую среду,
здоровье и безопасность людей.
- Потребность в разработке системы метрологического обеспечения процессов создания наноструктур в качестве оптимизированных переносчиков энергии.
- Потребность в системе метрологического обеспечения (включая терминологию, теорию, отображение информации и формирование изображений, моделирование), позволяющей использовать наноструктуры и принципы их функционирования при компоновке новых наноматериалов, предназначенных для использования в энергетике (перенос массы и энергии, регистрация данных, преобразование, производство).
- Потребность в разработке системы метрологического обеспечения и соответствующей инфраструктуры, адаптированной применительно к специфике синтеза наноматериалов для специальных применений в энергетике (например, при создании углеродных нанотрубок для хранилищ водорода).
- Необходимость описания свойств наноразмерных цеолитов и наноструктур, применяемых в катализаторах химических процессов при контроле состояния окружающей среды.
- Потребность в разработке системы метрологического обеспечения, необходимой для синтеза технологии изготовления диспергированных суспензий наночастиц без абсорбирующих добавок.
- Потребность в метрологическом обеспечении новых нанопреобразователей и других технических средств для обнаружения химических, биологических, радиологических и взрывоопасных веществ и материалов; наноматериалов для усовершенствования защитной одежды и фильтров, а также средств защиты от нападений.
Для преодоления данных барьеров национальные метрологические институты стран, с наиболее развитыми нанотехнологическими направлениями, создают специальные научно-исследовательские лаборатории, оснащенные современными средствами измерений, зачастую совмещенными с соответствующим технологическим оборудованием.
Наиболее известны подразделения метрологии соизмерен] рационального института стандартов и технологии - "N1ST (США), Национальной физической лаборатории - NPL (Великобритания), Физико- технического института - РТВ (Германия), Национального метрологического института - LNE (Франция).
Оснащение данных лабораторий включает в себя ряд приборов, позволяющих проводить измерения физических величин в нанометровом диапазоне. К ним относятся сканирующие электронные микроскопы (СЭМ), просвечивающие электронные микроскопы (ПЭМ), сканирующие туннельные микроскопы (СТМ)» атомно-силовые микроскопы (АСМ), микроскопы ближнего поля, конфокальные микроскопы, интерференционные микроскопы и ряд других приборов обеспечивающих наивысшее разрешение по измеряемым физическим величинам при нанометровых размерах исследуемого объекта.
Однако, в процессе исследований различных наноструктур возникло понимание, что для решения задач обеспечения единства измерений параметров наноструктур данной приборной базы недостаточно. Возникла необходимость значительно повысить точность измерений и увеличить количество измеряемых параметров.

Рисунок 4 - Эталонный манометрический комплекс национального метрологического института Франции (LNE) на основе АСМ.
Измерительный объем 300 х 300 мм х 50 мкм. Для обеспечения высокий точности измерений прибор размещается в помещении с высоким уровнем обеспыливания и термостабилизации. Применяются специальные меры
по защите от вибраций и акустических воздействий.
Поскольку пока не разработано приборов, основанных на новых физических принципах, повышение точности приборов приведенных выше достигается за счет увеличения стабильности параметров окружающей среды, обеспыливания, всесторонней защиты от различных внешних воздействий (рисунок 4).
Получение информации о различных физических параметрах нанообъекта во многих случаях может быть достигнуто только путем одновременного измерения ряда физических параметров. Поскольку при переносе объекта от одного прибора к другому ряд его свойства могут существенно измениться.
Это привело к созданию комбинированных приборов, позволяющих, например, без выноса образца в атмосферу исследовать один и тот же участок образца методами сканирующей электронной микроскопии, атомно-силовой микроскопии, ближнепольной оптической микроскопии, дифрактометрии, поляриметрии и т.д.
Приборы подобного типа разработаны и используются в Национальной физической лаборатории. Например, оптико-рентгеновский интерферометр и атомно-силовой микроскоп в комбинации с рентгеновским интерфе-рометром.
Ввиду того, что появляется большое количество нанострукту-рированных материалов с новыми свойствами, количество нормируемых параметров, требующих проведения измерений постоянно возрастает. Также возникает необходимость создавать стандартные образцы новых наноструктурированных материалов и аттестовывать их. Поэтому для создания и исследования новых свойств нанострукутрированных материалов необходимо иметь возможность проводить изготовление таких материалов, а также оказывать на них различные воздействия в процессе измерений.
Этим требованиям соответствует измерительно-технологическая установка высшей точности для создания и исследования нанострукутур, созданная в NIST (США). Данная установка считается одном из наиболее совершенных инструментов для исследований наноструктурированных материалов (рисунок 5).
Для повышения достоверности регистрации параметров нанобъекта его исследование осуществляется непосредственно сразу после изготовления, причем транспорт объекта из технологической камеры в измерительную осуществляется с помощью специального робота в сверхвысоком вакууме. Это позволяет, например, в течение нескольких часов исследовать свойства поверхности свободной от газового монослоя.
Аналогом данной установки является отечественный измерительно-технологический комплекс «Нанофаб», разработанный компанией «НТ- МДТ» (г. Зеленоград) (рисунок 6). Однако, к настоящему времени нет подтвержденных данных о реальных характеристиках и практических возможностях данного комплекса.
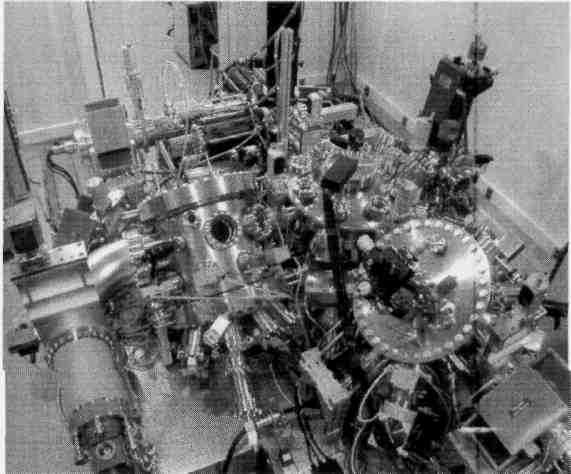
Рисунок 5 - Установка для создания и исследования наноструктур
(NIST, США) включает в себя:
- сканирующий туннельный микроскоп (СТМ) при сверхвысоком
- вакууме и высокоточном контроле температур -270 до -150 С;
- сверхпроводящий магнит создающий поле до 10 Т в области зонда;
- систему молекулярно-пучковой эпитаксии;
- систему приготовления образцов игольчатого типа для исследования на СТМ;
- систему транспорта образцов в сверхвысоком вакууме;
уникальную систему защиты от внешних физических полей.

Рисунок 6 - Измерительно-технологическая установка «Нанофаб»
обеспечивает создание и измерение образцов в сверхвысоком вакууме
с применением методов: МПЭ; фокусированного ионного пучка (ФИП);
АСМ; возможностью наращивания аналитического оборудования
и кластерного конфигурирования.
Исследование аппаратурного обеспечения наноизмерений ведущих метрологических центров мира позволяет сформулировать ряд принципов, которые должны быть положены в основу создания измерительно-технологического комплекса для обеспечения единства измерений параметров наноструктурированных объектов и материалов.
- Повышение точности измерений эталонных установок за счет снижения воздействий внешних шумовых полей на прибор путем экранирования внешних полей и стабилизации параметров окружающей среды.
2 Повышение точности измерения параметров нанобъектов за счет снижения воздействия окружающей среды на нанообъект путем транспорта его в вакууме и снижения времени между созданием нанообъекта и регистрацией его параметров.
3 Получение информации о свойствах наноструктурированных материалов путем одновременного проведения комбинированных измерений, основанных на различных физических принципах, а также оказания различных видов воздействий в процессе проведения измерений.
4 Для исследования новых свойств наноструктурированных материалов, а также моделирования и создания различных стандартных образцов свойств, состава и структуры в комплекс должны входить установки, позволяющие проводить оперативное изготовление таких образцов.
Исследование рынка современных приборов и оборудования показало,
что в области нанотехнологий имеется весьма незначительное количество
коммерчески доступных образцов уникальных многофункциональных
установок. Одной из немногих коммерческих доступных установок, позволяющих проводить создание и манипуляции с нанострукутрами, а также измерение их параметров методами СЭМ и различными видами структурного анализа является установка фирмы Карл Цейсе (Германия) Cross Beam 1540 (рисунок 7).

Рисунок 7 - Установка Cross Beam 1540 - уникальный комплекс
создания и исследования нанообъектов.
Установка Cross Beam 1540 оснащена двумя электромагнитными колоннами, обеспечивающими подачу на образец сфокусированного электронного и ионного пучков. Электронный пучок используется для наблюдения структуры образца, ионный пучок используется для создания и обработки образца. В электронном пучке достигается разрешение - 0,8 нм.
Установка оснащена детекторами позволяющими с высокий разрешением и контрастом наблюдать наноструктуру образца и следовать его состав. В их число входят:
- детектор отраженных электронов с селекцией по углу и по энергии;
- детектор вторичные электроны;
- детектор для работы в просвечивающем режиме;
- анализ катодолюминесценции;
- рентгеновский энергодисперсионный спектрометр;
- квадрупольный масс-спектрометр.
Установка CrossBeam 1540 штатно оснащена системой подачи в область ионного луча поочередно пяти газовых смесей и позволяет наносить вольфрам, углерод, платину, золото, а также дифторид ксенона.
Ионный пучок установки CrossBeam 1540 позволяет осуществлять ионно-лучевое травление образца, которое используется в различных исследовательских целях, а также при конструировании наноструктур (рисунок 8).
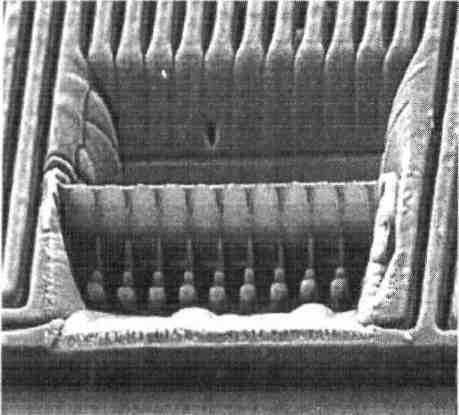
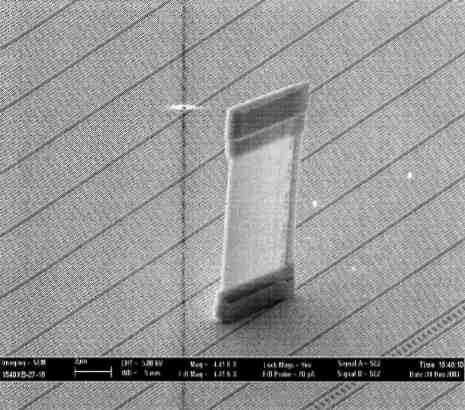
Рисунок 8 – Пластинчатая секция, для исследования на ПЭМ,
изготовленная с помощью ионного пучка Cross Beam 1540.
В России уже имеются две установки Cross Beam 1540, которые в 2006 году были поставлены фирмой Карл Цейсс в Санкт-петербургский и Дальневосточный госуниверситеты.
Для исследования атомарной структуры нанообъектов в составе
измерительно-технологического комплекса целесообразно иметь просве-чивающий электронный микроскоп (ПЭМ) . Рекордным по разрешению и одновременно коммерчески доступным является ПЭМ Либра 200 фирмы Карл Цейсс, обеспечивающий разрешение до 0,8 А (рисунок 9).
В состав измерительно-технологического комплекса необходимо включить приборы, обеспечивающие измерение оптико-физических параметров наноструктурированных материалов. К таким приборам относятся ближнепольный сканирующий оптический микро-фотолюминисцентный спектрометр NFS-200/300 фирмы Jasco (Великобритания).

Рисунок 9 – Высокоразрешающий просвечивающий электронный микроскоп Либра 200 с ускоряющим напряжением 200 КэВ.
Разрешение до 0,8 А.
Для исследования нанобъектов со сложной трехмерной топологией, в том числе в приложении нанобиотехнологий, в составе измерительно-технологического комплекса метрологического необходимо иметь конфокальный сканирующий микроскоп. Одним из лучших образцов таких приборов является конфокальный сканирующий микроскоп-спектрометр Leica TCS SPE, фирмы Leica Microsystems.
Таким образом, примерный состав измерительной аппаратуры для обеспечения единства измерений параметров наноструктурированных объектов и материалов в современном представлении должен включать:
- установку Cross Beam 1540 в полной комплектации - 2 млн. евро;
- просвечивающий электронный микроскоп Либра 200 - 2 млн. евро;
- ближенпольный микроскоп- спектрометр Jasco NFS-200/300 - 500 тыс. евро;
- конфокальный сканирующий микроскоп-спектрометр Leica TCS SPE - 350 тыс. евро.
Ориентировочная стоимость приборов для создания измерительного комплекса в указанной комплектации составляет около 4,85 млн. евро.
Приведенный пример показывает:
1 Метрологическое обеспечение нанотехнологий и нанопродукции крайне дорогостоящее мероприятие.
2 Среди высококачественного измерительного оборудования для нанотехнологий мало оборудования, разработанного и изготовленного в России.
ВЫВОДЫ
1 Метрология играет важнейшую роль при разработке и коммерциализации нанотехнологий и нанопродукции.
2 Переход к нанометрологии потребует значительного увеличения точности применяемых средств измерений (например, точность измерения длины должна возрасти в 10÷50 раз).
3 Значительно усложняются условия, в которых необходимо будет проводить измерения. Большая часть измерений будет выполняться в условиях высокого вакуума и, как правило, совмещаться с самим технологическим процессом.
4 Потребуется создание новых государственных первичных и рабочих эталонов.
5 Метрологическое обеспечение нанотехнологий и нанопродукции потребует значительных финансовых затрат.
6 Для повышения эффективности расходования средств, выделяемых на метрологическое обеспечение нанотехнологий, необходимо определить приоритетные направления развития нанотехнологий и нанопродукции.
