Элементарная теория работы полевых транзисторов физической основой работы полевого транзистора со структурой металл-диэлектрик-полупроводник является эффект поля
| Вид материала | Документы |
Содержание5.2.МОП ПТ с плавающим затвором. I(t) - величала инжекционного тока в момент времени t 5.4. Полевой транзистор с затвором в виде р |
- Лекция 4, 201.1kb.
- Методические указания к лабораторной работе по исследованию статических характеристик, 104.56kb.
- Полупроводниковые приборы, 355.8kb.
- Л. М. Чирок Математическая модель электрохимического датчика, 44.36kb.
- "Анализ и расчет статических параметров транзистора в схеме с общим затвором." по курсу, 229.13kb.
- Программа междисциплинарного экзамена для поступления в магистратуру по направлению, 51.62kb.
- Вприближении двухмерной модели атома водорода рассмотрены свойства мелких примесных, 25.62kb.
- Работа № ключевой режим работы транзистора, 358.55kb.
- Аннотация дисциплины, 786.67kb.
- 1. Какие требования предъявляются к транзисторам рэ в стабилизаторах с импульсивным, 463.58kb.
Рассмотрим RC -цепочку, состоящую из последовательно соединенных нагрузочного сопротивления
 и полевого транзистора с изолированным затвором, приведенную на рис.18. Если в такой схеме МДП транзистор открыт, сопротивление его канала составляет десятки или сотни Oм, все напряжение питания падает на нагрузочном сопротивлении RН и выходное напряжение Uвых близко к нулю.
и полевого транзистора с изолированным затвором, приведенную на рис.18. Если в такой схеме МДП транзистор открыт, сопротивление его канала составляет десятки или сотни Oм, все напряжение питания падает на нагрузочном сопротивлении RН и выходное напряжение Uвых близко к нулю.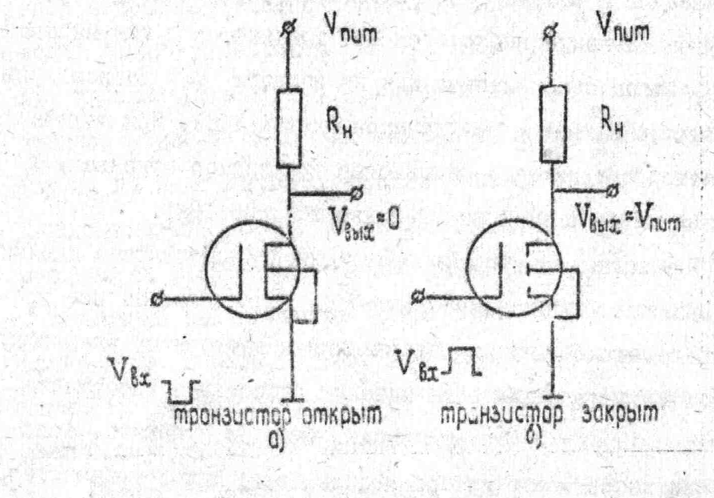
Рис.18. Схема, поясняющая работу МДП транзистора в качестве элемента запоминающего устройства.
Если МДП транзистор при таком соединении закрыт, сопротивление между областями истока и стока велико (сопротивление р-n перехода при обратном включении), всё напряжение питания падает на транзисторе и выходное напряжение Uвых близко к напряжению питания Uпит. Как видно из приведенного примера, на основе системы резистор-МДП транзистор легко реализуется элементарная логическая ячейка с двумя значениями: ноль и единица. Реализовать такую схему можно несколькими вариантами. В одном из них выбирается МДП транзистор со встроенным каналом и при напряжении на затворе равном нулю реализуется случай, соответствующий рис.18а. После подачи на затвор напряжения VG транзистор закрывается и реализуется условие, показанное на рис.18б. В другом варианте выбирается МДП транзистор с индуцированным каналом и при напряжение на затворе VG равном нулю транзистор закрыт и реализуется случай 18б). При подаче на затвор обедняющего напряжения транзистор открывается , и реализуется случай, соответствующий рис.18а).
Одним из недостатков приведенной элементарной ячейки информации является необходимость подведения на все время хранения информации напряжения к затворному электроду. При отключении напряжения питания записанная информация теряется. Этого недостатка можно было бы избежать, если в качестве МДП транзистора использовать такой транзистор, у которого регулируемым обрезом можно было бы менять пороговое напряжение VT. Тогда при положительном пороговом напряжении VT>0 ( n - канальный транзистор) МДП транзистор закрыт и реализуется случай 18б). При отрицательном пороговом напряжении VT<0 МДП - транзистор закрыт и реализуется случай 18а).
5.1. МНОП транзистор
Величина порогового напряжения VT определяется уравнением (4.28). Как видно из этого уравнения, для изменения величины порогового напряжения VT необходимо:
а) изменить легирование подложки NA (для изменения объёмного положения уровня Ферми
 , разности paбот выхода
, разности paбот выхода  , заряда акцепторов в области обеднения QВ),
, заряда акцепторов в области обеднения QВ),б) изменить плотность поверхностных состояний
 , изменить встроенный в диэлектрик заряд Qох , г) изменить напряжение смещения канал-подложка VSS (для изменения заряда акцепторов QВ в слое обеднения). Поскольку нформацию в ячейку необходимо перезаписывать многократно, случаи а) и б) для этого оказываются непригодными. Случай г) не подходит вследствие того, что при отключении напряжения информация не сохраняется. Таким образом, для реализации энергонезависимого репрограммируемого полупроводникового запоминающего устройства (РПЗУ) необходим МДП транзистор, в котором обратимым образом было бы возможно изменять пороговое напряжение VT за счет изменения встроенного в диэлектрик заряда Qох.
, изменить встроенный в диэлектрик заряд Qох , г) изменить напряжение смещения канал-подложка VSS (для изменения заряда акцепторов QВ в слое обеднения). Поскольку нформацию в ячейку необходимо перезаписывать многократно, случаи а) и б) для этого оказываются непригодными. Случай г) не подходит вследствие того, что при отключении напряжения информация не сохраняется. Таким образом, для реализации энергонезависимого репрограммируемого полупроводникового запоминающего устройства (РПЗУ) необходим МДП транзистор, в котором обратимым образом было бы возможно изменять пороговое напряжение VT за счет изменения встроенного в диэлектрик заряда Qох.Наиболее распространенными РПЗУ, в которых реализован этот принцип, являются РПЗУ на основе полевых транзисторов со структурой металл-нитрид-окисел-полупроводник (МНОП транзисторы) и на основе полевых транзисторов с плавающим затвором.
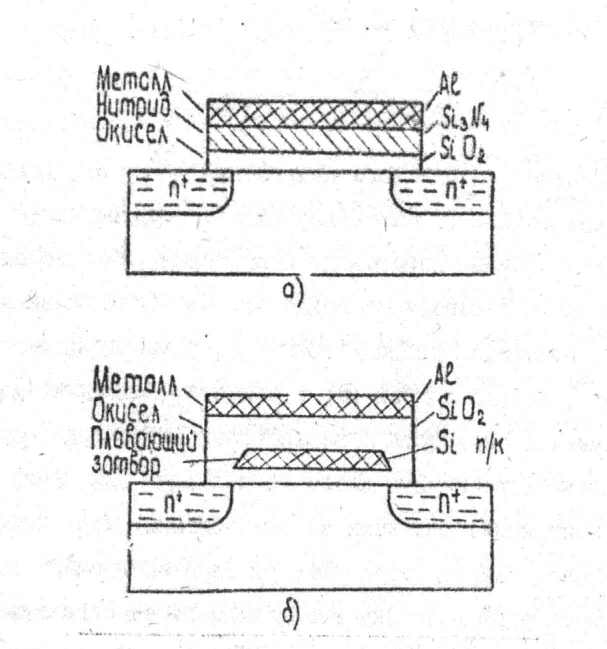
Рис.19. Топология полупроводниковых запоминающих устройств;
а) МНОП транзистор, б) МОП ПТ с плавающим затвором
На рис.19 а) и б) приведена схема, показывающая основные конструктивные элементы МНОП ПТ и МОП ПТ с плавающим затвором.
МНОП ПТ в качестве подзатворного диэлектрика используется двухслойное покрытие. В качестве первого диэлектрика используется туннельно прозрачный слой ( dox < 50А) двуокиси кремния. В качестве второго диэлектрика используется толстый (d
 1000А) слой нитрида кремния. Нитрид кремния Si3N4 имеет глубокие ловушки в запрещённой зоне и значение диэлектрической постоянной
1000А) слой нитрида кремния. Нитрид кремния Si3N4 имеет глубокие ловушки в запрещённой зоне и значение диэлектрической постоянной  в два раза более высокое, чем диэлектрическая постоянная двуокиси кремния SiO2. Ширина запрещенной зоны нитрида Si3N4 меньше, чем ширина запрещенной зоны окисла SiO2. На рис.20 а) приведена зонная диаграмма МНОП транзистора. Рассмотрим основные физические процессы, протекающие в МНОП транзисторе при работе в режиме запоминающего устройства. При подаче импульса положительного напряжения + VGS на затвор вследствие разницы в величинах диэлектрических постоянных окисла и нитрида в окисле возникает сильное электрическое поле. Это поле, вызывает, как показано на рис.20 б), туннельную инжекцию электронов из полупроводника через окисел в нитрид. Инжектированные электроны захватываются на глубине уровня ловушек в запрещенной зоне нитрида кремния, обуславливая отрицательный по знаку встроенный в диэлектрик заряд. После снятия напряжения с затвора инжектированный заряд длительное время хранится на ловушечных центрах, что соответствует существованию встроенного инверсионного канала. При подаче импульса отрицательного напряжения -VGS на затвор происходит туннелирование электронов с ловушек в нитриде кремния в зону проводимости полупроводника, как показано на рис.20 в). При снятии напряжения с затвора зонная диаграмма МНОП структуры снова имеет вид, как на рис.20 а), и инверсионный канал исчезает.
в два раза более высокое, чем диэлектрическая постоянная двуокиси кремния SiO2. Ширина запрещенной зоны нитрида Si3N4 меньше, чем ширина запрещенной зоны окисла SiO2. На рис.20 а) приведена зонная диаграмма МНОП транзистора. Рассмотрим основные физические процессы, протекающие в МНОП транзисторе при работе в режиме запоминающего устройства. При подаче импульса положительного напряжения + VGS на затвор вследствие разницы в величинах диэлектрических постоянных окисла и нитрида в окисле возникает сильное электрическое поле. Это поле, вызывает, как показано на рис.20 б), туннельную инжекцию электронов из полупроводника через окисел в нитрид. Инжектированные электроны захватываются на глубине уровня ловушек в запрещенной зоне нитрида кремния, обуславливая отрицательный по знаку встроенный в диэлектрик заряд. После снятия напряжения с затвора инжектированный заряд длительное время хранится на ловушечных центрах, что соответствует существованию встроенного инверсионного канала. При подаче импульса отрицательного напряжения -VGS на затвор происходит туннелирование электронов с ловушек в нитриде кремния в зону проводимости полупроводника, как показано на рис.20 в). При снятии напряжения с затвора зонная диаграмма МНОП структуры снова имеет вид, как на рис.20 а), и инверсионный канал исчезает.Оценим величину инжектированного заряда, необходимую для переключения МНОП транзистора. Пусть величина
 ,
,  ,
,
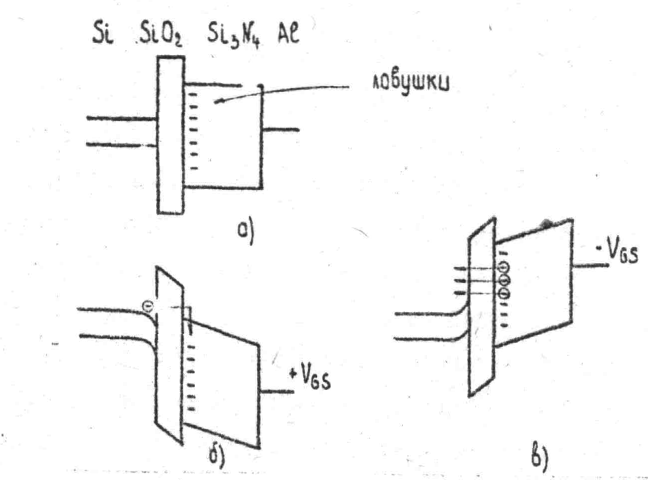
Рис.20. Зонная диаграмма МНОП транзистора. а) Напряжение на затворе равно нулю, ловушки не заполнены, б) запись информационного заряда, в) стирание информационного заряда.
 (5.1)
(5.1)Подставив численно значения в (5.1),получаем
 . Считая, что захват идет в энергетический интервал 1эВ в запрещенной зоне нитрида и в слой толщиной 100А, получаем, что энергетическая плотность объемных ловушек Nt в нитриде должна быть порядка 2·1018см-3эВ-1.
. Считая, что захват идет в энергетический интервал 1эВ в запрещенной зоне нитрида и в слой толщиной 100А, получаем, что энергетическая плотность объемных ловушек Nt в нитриде должна быть порядка 2·1018см-3эВ-1.5.2.МОП ПТ с плавающим затвором.
Полевой транзистор с плавающим затвором по принципу работы похож на МНОП транзистор. Только в транзисторах с плавающим затвором инжектированный заряд хранится на плавающем затворе, находящемся между первым и вторым подзатворными диэлектрическими слоями. Схема, поясняющая устройство МОП ПТ с плавающим затвором, приведена на рис,18. б).
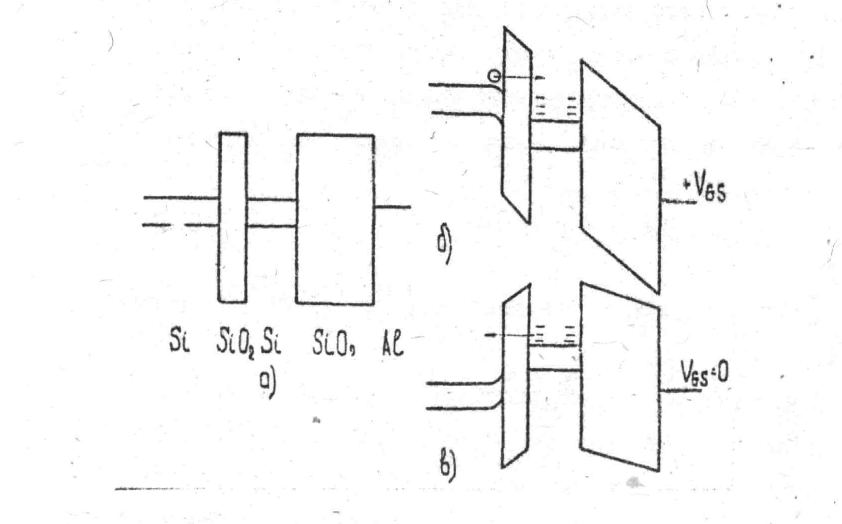
Рис.21. Зонная диаграмма МОП ПТ с плавающим затвором:
а) напряженная на затворе VGS равно нулю, плавающий затвор не заряжен,
б) процесс записи информационного заряда импульсом напряжения + VGS ,
в) МОП ПТ при нулевом напряжении на затворе в режиме хранения информационного заряда.
В качестве материала для плавающего затвора используется поликристаллический кремний, легированный фосфором.
На рис.21 a) приведена зонная диаграмма такого транзистора. Рис.21 б) поясняет механизм записи информационного заряда путем туннельной инжекции из полупроводника на плавающий затвор. На рис.21 в) приведена зонная диаграмма МОП ПТ с плавающим затвором после записи заряда и снятия напряжения с затвора. Возможно частичное растекание наполненного информационного заряда из-за туннелирования электронов с плавающего затвора обратно в полупроводник.
Рассмотрим основные соотношения, определяющие характер накопления инжектированного заряда на плавающем затворе полевого транзистора. Величина заряда Qox(
 ) равна
) равна (5.2)
(5.2)где I(t) - величала инжекционного тока в момент времени t .
Как видно из зонной диаграммы на рис.21, инжекция носителей из полупроводника через первый слой окисла на плавающий затвор осуществляется путем прямого туннелирования через трапецеидальный барьер. Величина туннельного тока I(t) описывается соотношением
 (5.3)
(5.3)Уравнение (5.3) напоминает выражение для туннельного тока Фаулера-Нордгейма из твердого тела в вакуум через треугольный барьер. Постоянные величины А и В, входящие в (5.3), зависят от типа полупроводника и высоты потенциальных барьеров на границе.
Накапливаемый на плавящем затворе инжектированный заряд Q(
 ) будет вызывать уменьшение напряженности электрического поля Еох в первом диэлектрике. Величина электрического поля Еох, обуславливающая туннелирование ,
) будет вызывать уменьшение напряженности электрического поля Еох в первом диэлектрике. Величина электрического поля Еох, обуславливающая туннелирование ,  (5.4)
(5.4)Первое слагаемое в соотношении (5.4) дает значение электрического поля Еох за счет приложенного напряжения к затвору VG, второе слагаемое - за счет накопления инжекционного заряда. В том случае, если в качестве второго диэлектрика в МОП ПТ с плавающим затвором используется двуокись кремния, в (5.4) величины диэлектрических постоянных необходимо выбрать одинаковыми.
Из уравнений (5.2-5.4) следует, что при малых временах
 наполненный заряд Q(
наполненный заряд Q( ) мал, и линейно возрастает со временем
) мал, и линейно возрастает со временем  , поскольку поле в окисле Еох и туннельный ток I(t) постоянны. При больших временах наступает насыщение наполнения инжектированного заряда
, поскольку поле в окисле Еох и туннельный ток I(t) постоянны. При больших временах наступает насыщение наполнения инжектированного заряда  Q (
Q ( ) . Соотношения (5.2-5.4) позволяют на основе расчета выбрать наиболее оптимальные режимы записи и стирания информационного заряда.
) . Соотношения (5.2-5.4) позволяют на основе расчета выбрать наиболее оптимальные режимы записи и стирания информационного заряда.5.3. Приборы с зарядовой связью
Новым типом полевых полупроводниковых приборов, работающих в динамическом режиме, являются приборы с зарядовой связью (ПЗС). На рис.22 приведена схема, поясняющая устройство и основные физические принципы работы ПЗС. Приборы с зарядовой связью представляют собой линейку или матрицу последовательно расположенных МДП структур. Величина зазора между соседними МДП структурами невелика и составляет (1÷2) мкм. ПЗС - элементы служат для преобразования оптического излучения в электрические сигналы и передачи информации от одного элемента электронной схемы к другому.
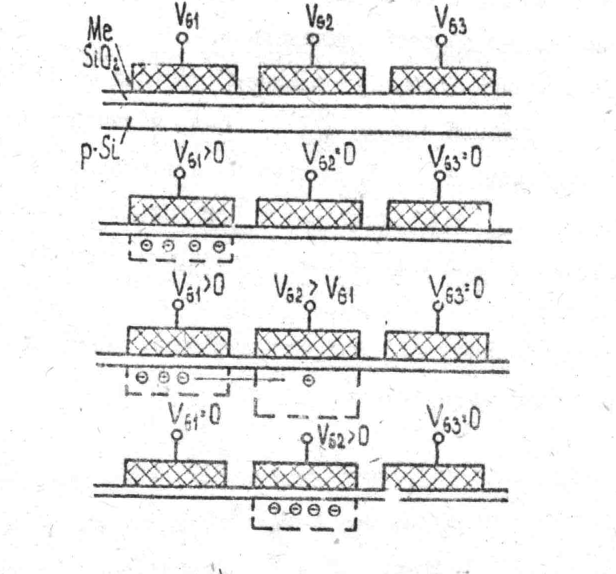
Рис.22. Устройство и принцип работы приборов с зарядовой связью.
Рассмотрим принцип работа ПЗС. При подаче обедняющего импульса напряжения VG1 на затвор I- го элемента в ОПЗ полупроводника образуется неравновесный слой обеднения. Для электронов в полу проводнике р-типа это соответствует формированию под затвором I- го элемента потенциальной ямы. Известно, что неравновесное состояние сохраняется в период временя t порядка времени генерационно-рекомбинационных процессов
 ген . Поэтому все остальные процессы в ПЗС-элементах должны проходить за времена меньше
ген . Поэтому все остальные процессы в ПЗС-элементах должны проходить за времена меньше  ген. Пусть в момент времени t 1>>
ген. Пусть в момент времени t 1>> ген в ОПЗ под затвор I- го элемента инжектирован каким-либо образом информационный заряд электронов.(Рис. 22 б ). Теперь в момент времени t2> t1 но t2 <<
ген в ОПЗ под затвор I- го элемента инжектирован каким-либо образом информационный заряд электронов.(Рис. 22 б ). Теперь в момент времени t2> t1 но t2 << ген на затвор 2- го ПЗС элемента подадим напряжение VG2>VG1, способствующее формированию более глубокой потенциальной ямы для электронов под затвором 2- го элемента. Возникнет вследствие диффузии и дрейфа поток электронов из ОПЗ под I- м элементом в ОПЗ под вторым элементом, как показано на рис.22 в). Когда весь информационный заряд перетечет в ОПЗ 2- го ПЗС-элемента, напряжение на затворе VG1 снимается, а на затворе VG2 уменьшается до значения, равного VG1 (рис.22 г). Произошла nepeдача информационного заряда. Затем цикл повторяется и заряд передаётся дальше в ОПЗ З-го ПЗС-элемента. Для того, чтобы приборы с зарядовой связью эффективно функционировали, необходимо, чтобы время передачи t пер от одного элемента к другому было много меньше времени генерационно-рекомбинационных процессов (t пер<<
ген на затвор 2- го ПЗС элемента подадим напряжение VG2>VG1, способствующее формированию более глубокой потенциальной ямы для электронов под затвором 2- го элемента. Возникнет вследствие диффузии и дрейфа поток электронов из ОПЗ под I- м элементом в ОПЗ под вторым элементом, как показано на рис.22 в). Когда весь информационный заряд перетечет в ОПЗ 2- го ПЗС-элемента, напряжение на затворе VG1 снимается, а на затворе VG2 уменьшается до значения, равного VG1 (рис.22 г). Произошла nepeдача информационного заряда. Затем цикл повторяется и заряд передаётся дальше в ОПЗ З-го ПЗС-элемента. Для того, чтобы приборы с зарядовой связью эффективно функционировали, необходимо, чтобы время передачи t пер от одного элемента к другому было много меньше времени генерационно-рекомбинационных процессов (t пер<< ген). Не должно быть потерь информационного заряда в ОПЗ вследствие захвата на поверхностные состояния, в связи с чем требуются МДП структуры с низкой ( NSS
ген). Не должно быть потерь информационного заряда в ОПЗ вследствие захвата на поверхностные состояния, в связи с чем требуются МДП структуры с низкой ( NSS  1010см-2эВ-1) плотностью поверхностных состояний.
1010см-2эВ-1) плотностью поверхностных состояний.5.4. Полевой транзистор с затвором в виде р - n перехода
Рассмотрим характеристики полевого транзистора, затвор у которого выполнен в виде р-n перехода. На рис.23 показана одна из возможных топологий такого транзистора. Омические контакты к левой и правой граням полупроводниковой подложки будут являться истоком и стоком, область квазинейтрального объема заключенная между обедненными областями р-n переходов-каналом, а сильно легированные n+ области сверху и снизу - затвором полевого транзистора. Конструктивно ПТ с затвором в виде р-n перехода может быть выполнен с использованием планарной технологии и в различных других вариантах.
При приложении напряжения VGS к затвору ПТ, обеспечивающего обратное смещение р-n перехода (VGS >0 ), происходит расширение обедненной области р - n перехода в полупроводниковую подложку, поскольку затвор легирован существенно сильнее, чем подложка (ND>>NA). При этом уменьшается поперечное сечение канала, а следовательно, увеличивается его сопротивление. Приложенное напряжение исток - сток VDS вызовет ток в цепи канала полевого транзистора. Знак напряжения VDS необходимо выбирать таким образом, чтобы оно также вызывало обратное смещение затворного р-n перехода, то есть было бы противоположно по знаку напряжению VGS. Таким образом, полевой транзистор с затвором в виде р-n перехода представляет сопротивление, величина которого регулируется внешним напряжением.
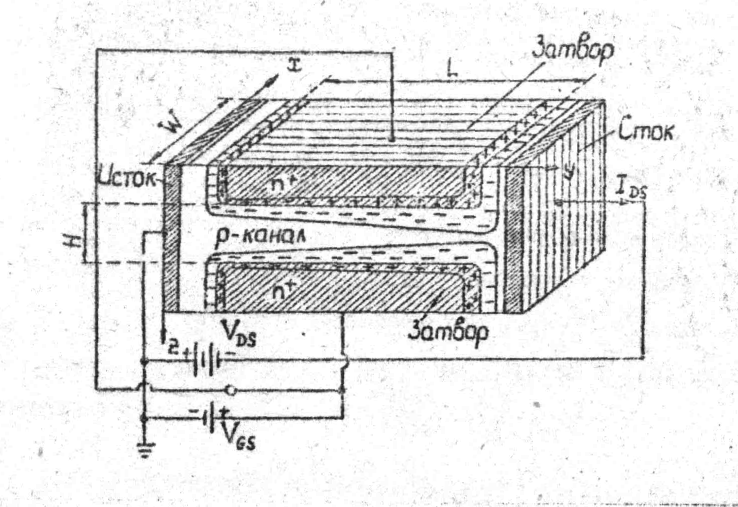
Рис. 23. Схематическое изображение полевого транзистора с затвором в виде р-n перехода.
Получим вольтамперную характеристику транзистора. Здесь, как и ранее, ось у направим вдоль канала, ось х - по ширине канала, ось z - по глубине канала. Обозначим L, W, Н длину, ширину и высоту канала при отсутствии напряжения на транзисторе(VGS = VDS=0).
При приложении напряжения к затвору VGS >0 и стоку VDS<0 произойдёт расширение обеднённой области р-n перехода на величину
 , равную
, равную (5.3)
(5.3)Поскольку напряжение исток-сток VDS распределено вдоль канала VDS(у), то изменение ширины канала транзистора будет различно по длине канала. При этом высота канала h(y) будет
 (5.4)
(5.4)Введем напряжение смыкания VG0 напряжение на затворе, когда в квазиравновесных условиям (VDS=0 ) обедненные области р-n переходов смыкаются h(y) =0.
Тогда из (5.4 ) следует, что
 (5.5)
(5.5)Соотношение (5.4) с учетом (5.5) можно переписать в виде
 (5.6)
(5.6)Выделим на длине капала участок от у до у+dy , сопротивление которого будет dR(y). При токе канала IDS на элементе dy будет падение напряжения dVDS (y), равное
 (5.7)
(5.7)Величина сопротивления dR(y) будет
 (5.8)
(5.8)Подставим (5.8) в (5.7) и проведем интегрирование по длине канала
 (5.9)
(5.9)Поскольку удельное объемное сопротивление
 равно
равно  , преобразуем величину
, преобразуем величину 
 (5.10)
(5.10)Здесь
 - заряд свободных дырок в канале на единицу площади.
- заряд свободных дырок в канале на единицу площади.Подставляя (5.10) в (5.9) я проведя интегрирование, получаем следующую зависимость тока стока IDS от напряжения на затворе VG и стоке VDS для полевого транзистора с затвором в виде р-n перехода.
 (5.11)
(5.11)При малых значениях напряжения исток-сток в области плавного канала VDS<
 (5.12)
(5.12)Если сравнить соотношение (5.12) с выражением (3.10) для тока стока МДП полевого транзистора в области плавного канала, то видно, что эти выражения совпадают при малых значениях напряжения VDS.
Из (5.6) следует, что при напряжениях VG < VG0 всегда можно найти такое напряжение на стоке VDS , когда вблизи стока произойдет смыкание канала h(y=L,VG, VDS) =0.
Аналогично процессам в МДП ПТ это явление называется отсечкой. Из (5.6) следует, что напряжение отсечки
 будет
будет (5.13)
(5.13)Также заметим, что выражение (5.13) аналогично соотношению (3.11) для напряжения отсечки МОП ПТ, а напряжение смыкания VG0 имеет аналогом величину порогового напряжения VТ.
По мере роста напряжения исток-сток VDS точка отсечки перемещается от истока стоку. При этом аналогично МДП ПТ наблюдается независимость тока стока от напряжения на стоке и эффект модуляции длины канала. Подставляя (5.13) в (5.11) получаем зависимость тока стока IDS в области отсёчки для полевого транзистора с затвором в виде р-n перехода
 (5.14)
(5.14)В области отсечки выражение (5.14) хорошо аппроксимируется квадратичной зависимостью вида
 . (5.15)
. (5.15)На рис.24 показаны вольтамперные характеристики в ПТ с затвором в виде р-n перехода. Отличительной особенностью их является тот факт, что при напряжении на затворе VG = 0 канал транзистора открыт и величина тока через него максимальна.
Быстродействие ПТ с затвором в виде р-n переходов обусловлено зарядкой барьерных емкостей СG затворных р-n переходов через сопротивление канала RK. Величина времени заряда
 . Емкость затвора СG и сопротивление канала RK равны
. Емкость затвора СG и сопротивление канала RK равны
 ;
;  ; (5.16)
; (5.16) (5.17)
(5.17)Выражение (5.17) имеет минимальное значение при ширине обеднённой области
 , при этом граничная частота
, при этом граничная частота . (5.18)
. (5.18)При значениях H=L для кремния (
 ) с удельным сопротивлением
) с удельным сопротивлением  , равным
, равным  =1Ом·см, граничная частота будет составлять величину несколько гигагерц.
=1Ом·см, граничная частота будет составлять величину несколько гигагерц.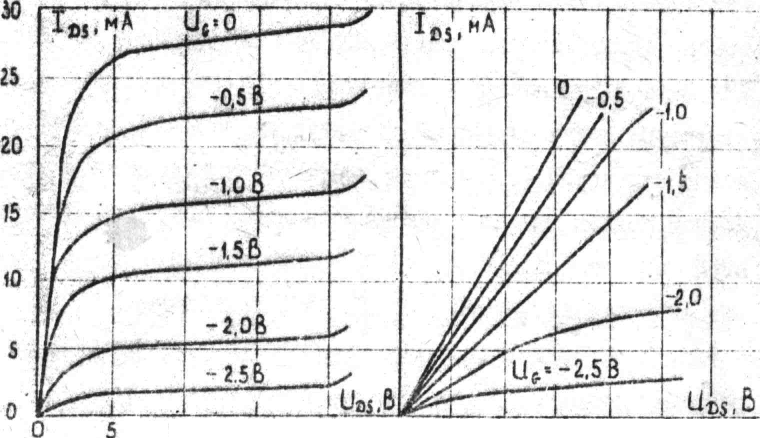
Рис.24. а) Выходные характеристики транзистора КП 302Б; б) Начальные участки выходных характеристик транзистора КП 302Б.
